Биполярные и полевые СВЧ транзисторы
Биполярные и полевые СВЧ транзисторы
1 Биполярные СВЧ транзисторы
В основе работы полупроводниковых СВЧ БТ и ПТ лежат те же физические процессы, которые определяют работу их на НЧ и ВЧ. Однако ряд факторов ограничивает использование НЧ и ВЧ транзисторов на СВЧ и требует решения ряда конструкторских и технологических задач.
Следует отметить, что частотный диапазон транзистора (БТ) ограничивается временем переноса носителей заряда через пространство активного взаимодействия. Это время для БТ оценивается суммой времен задержки, характеризующих последовательные стадии пролета от эмиттера к коллектору: эк = 0,5/fт = э + к + с,
где э, к времена, определяющие заряд эмиттерных и коллекторных емкостей; в, с времена задержки в базовом и коллекторном р-n переходе, fт - граничная частота.
Можно показать, что э = RэСэ + э, где Rэ = (Iэ/Uэ)1 сопротивление, Сэ емкость эмиттера, а э = d2э(2D00)1 время рассасывания не основных носителей в эмиттерном слое, dэ глубина залегания эмиттерного перехода, Dэ коэффициент диффузии не основных носителей заряда в эмиттере, 0 - коэффициент усиления по току.
Время задержки сигнала в базовом слое в случае однородного легирования базы, в которой скорость диффузионного пролета Vдиф = (D/n)(dn/dx) 2Dв/dв равно в = d2б(2Dв)1, где dв толщина базы в направлении тока базы, Dв коэффициент диффузии не основных носителей в базе.
При неоднородном легировании базы в ней может образоваться внутреннее поле Евнутр, приводящее к значительному ускорению пролета базы и если Евнутр = const, то
в = d2в{2Dв[1 + (Евнутр/Е0)3/2]}1, где Е0 = 2D/dв.
Время задержки в обедненном слое коллекторного р-n-перехода благодаря сильному полю в нем определяется дрейфом с предельной скоростью Vнас и при оценках принимается равным половине времени пролета c = Lк/2Vнас.
Время заряда обедненной емкости коллектора к = RкСк, где Rк – последовательное сопротивление коллектора. Полным временем задержки определяется граничная частота fт
fт = 1/2эв , (1)
которая для БТ соответствует частоте, при которой коэффициент усиления по току в режиме КЗ выхода схемы с ОЭ = (Iк/IБ) равен единице. Условие = 1, соответствует уменьшению коэффициента усиления по току в схеме с ОБ () в два раза (т.к. ( ).
Для БТ можно оценить конструкторско-технологические решения, которые позволяют создать транзистор, работающий в СВЧ диапазоне.
Исходным материалом планарного БТ служит пленка высокоомного Si-n, создаваемая эпитаксиальным наращиванием на Si подложку, на которой формируется вывод коллекторного контакта. Методом ступенчатой фотолитографии в изолирующей пленке создают окна, через которые в несколько стадий вводят легирующие примеси и формируют область базы с проводимостью р-типа, низкоомную приконтактную область базы р+, а в дальнейшем – эмиттерную область с проводимостью n+-типа. Металлическая пленка Э, Б и К обеспечивает подачу управляющих и питающих напряжений.
На границе Э-Б создается обедненный подвижными носителями заряда эмиттерный р-n-переход, а на границе Б-К-коллекторный.
В СВЧ транзисторах принимают меры по уменьшению времени переноса заряда через базу, для чего уменьшают размер lб. Современная технология позволяет реализовать б до десятых долей микрона. Наличие сверхтонкой базы является одной из особенностей СВЧ БТ.
Однако при уменьшении толщины базы снижается пробивное напряжение коллектора, а следовательно уменьшается выходная мощность. Следовательно, для СВЧ-транзисторов значение выходной мощности единичного транзистора снижается (компенсация достигается объединением в одном корпусе нескольких структур).
Сокращение времени переноса носителей через базу возможно также и за счет обеспечения преимущественно дрейфового (а не диффузионного) характера переноса. Дрейфовая скорость может существенно превышать скорость диффузионного движения, если создать в базе внутреннее ускоряющее поле. Для этого при изготовлении дрейфового транзистора легирующие примеси в базе распределяются неравномерно.
Например, для базы р-типа обеспечивают превышение концентрации акцепторных примесей у эмиттера по сравнению с концентрацией (акцепторов) у коллектора. Можно показать, что в случае экспоненциального распределения примесей в базе напряженность электрического поля оказывается постоянной по толщине и определяется отношением концентраций примеси на границах базы
Евнутр = тlб-1lnNбэ/Nбк, (2)
где т = kT/q температурный потенциал, lб толщина базы.
Величину m = Евнутрlб/2т называют фактором поля. Он характеризует соотношение между напряжением в базе за счет внутреннего поля и температурным потенциалом и для кремния достигает 10. Так, если при 3000К т = 0,25 мВ и m = 2, то в базе с толщиной 0,3 мкм возникает поле порядком 4 кВ/см.
В дрейфовых транзисторах время переноса заряда через базу в m раз меньше по сравнению с бездрейфовыми (т.к. дрейфовая скорость равна диффузионной при электрическом поле порядка 1 В/см, то в реальных Евнутр >> 1 В/см, то можно заведомо не принимать во внимание диффузионный перенос носителей). Граничная частота коэффициента переноса тока также увеличивается в m раз, т.е. fтдр = mfтбездрейф.
Уменьшение толщины базы (кроме снижения мощности) ведет еще и к увеличению сопротивления базы в поперечном направлении, что увеличивает постоянную времени заряда Cк р-n-перехода и, следовательно, снижает fт. Для снижения влияния роста Rк под базовым выводом легируют область полупроводника, создавая низкоомный слой р+ - типа. Тем не менее протекание базового тока параллельно плоскости кристалла приводит к возникновению неравномерного падения напряжения на распределенном сопротивлении материала базы. (Протекание тока базы обусловлено вводом и выводом носителей заряда через базу для обеспечения ее электронейтральности). Возникающие из-за тока базы падение напряжения на эмиттерном переходе в центре эмиттера оказывается меньше падения напряжения у края.
Плотность тока эмиттера экспоненциально зависит от напряжения на р-n-переходе.
Рис.1 Рис.2
Поэтому, падение напряжения вдоль оси Х в тонкой базе всего в несколько т приведет к различию в значении jэ примерно на порядок (jэx=0 < jэx=l/2). Возникает эффект “оттеснения тока эмиттера” (рис.1), для устранения которого эмиттер выполняют в виде узких полосок (увеличивают их длину по координате Z для получения нужного тока эмиттера, а для выравнивания напряжения вдоль их располагают в виде большого числа отдельных полосок, до 15 штук, между которыми располагают полоски выводов базы) т.е. формируют гребенчатую структуру (рис.2).
Конфигурация эмиттера и базы определяют fт, причем для ее увеличения БТ должны иметь максимальный периметр эмиттера при минимальной площади. Первое требование – обеспечивает необходимость равномерного распределения тока эмиттера, второе – уменьшение емкости эмиттера, снижающей уровень инжекции и шунтирующей эмиттерный переход.
В виде гребенчатой структуры реализованы эмиттеры с lэ = 1мкм, fмакс = 40/(lэ + 2t), где l, t – d мкм.
Для создания более мощных БТ используют объединение в одном кристалле до 150 единичных структур с сохранением большого отношения периметр/площадь. В многоэмиттерных структурах реализуют полоски низкоомного р+ слоя в кристалле, а внутри каждой ячейки располагают прямоугольный эмиттер. Вывод эмиттера изолирован от базовой сетки слоем SiO2.
Внешние выводы делают в виде коротких полосок (под МПЛ), что снижает их паразитные параметры С и L. Причем транзисторы выполняют без внешнего металлического корпуса.
В заключении следует указать еще одну величину: fмакс = [h21бfт/(8rбСк)]0,5, fмакс = fгр на которой 20,50/2, которая характеризует предельные частотные возможности БТ. На частотах выше fмакс БТ перестает быть активным элементом, т.е. только поглощает подводимую мощность. Генерация или усиление в этом случае невозможны ни при каких схемных включениях.
Частотные зависимости модулей коэффициентов передачи для схем с ОБ и ОЭ определяются частотами h21э и h21б, на которых коэффициент усиления по мощности уменьшается в 2 раза по сравнению с максимальным, причем h21б > h21э и определяются через снижение коэффициента передачи тока h21i (h21б = Iэ/IкUк=0 , h21э = Iк/IбUк=0 ) до значения 20,5h21б,э/2 (рис.3).
Рис.3
Следует помнить, что частоты h21э,б называть граничными нельзя, т.к. низкочастотное значение h21э 0 40, и при частотах выше h21э транзистор вполне может работать, (т.о. для повышения fгр необходимо снижать rб, Ск, что является противоречивым требованием).
Современные транзисторы БТ работают до 15 20 ГГц. Получено: Рмакс непр = 300 Вт на частоте f = 1 ГГц; 20 Вт на 3 ГГц; 1 Вт на 10 ГГц; 0,1 Вт на 14 ГГц, КПД 1 3 ГГц - 50%, 14 15 ГГц – 20%, Кшума = 2,5 3,0 дБ на 2-4 ГГц; 7,0 дБ на частотах более 10 ГГц.
Гетероструктурные БТ
Радикально повысить быстродействие БТ можно, если увеличить легирование базы без изменения эффективности эмиттера, что возможно при использовании в качестве эмиттера-гетеропереход. Пример гетеро-n-р-перехода с широкозонной n-областью приведен на рис.4.
“Встроенное” поле на переходе оказывается различным для электронов и дырок, оно и препятствует току дырок из р- в n-область. В рассматриваемом случае дырочный ток уменьшается (в exp(-E/kT), где E - дополнительный гетеробарьер для дырок), поэтому эффективность эмиттера э будет близка к 1, даже если уровень легирования р-области (базы) выше, чем n-области (эмиттера)
(3)
Различают плавные и резкие гетеропереходы рис.4.
Рис.4
При этом величина E в плавном гетеропереходе (варизонном кристалле) приблизительно равна разности ширин запрещенных зон Eз. При этом в плавном гетеропереходе (использован в качестве эмиттера) увеличение барьера для дырок создано за счет разности ширины запрещенных зон, а в резком оно определяется величиной Ev как показано на рис.4
В резком гетеропереходе созданном между GaAAs – GaAs барьер может достигать величины более 10 кT, что вполне достаточно для снижения более чем на порядок второго множителя, определяемого эффективность эмиттера Э.
Следует заметить, что повышение эффективности эмиттера в кремниевых БТ имеет место также при использовании поликристаллического кремния в качестве более широкозонного материала для эмиттера.
Перспективным материалом для широкозонного эмиттера является также CrSi. Такие эмиттеры позволяют избежать туннельного эффекта при легировании базы до 1019 см-3 и более, т.о. достигается тонкий слой базы и тонкие обедненные слои, а главное – снижение на порядок величины сопротивления базы.
Гетеропереход широкозонный коллектор-узкозонная база позволяет исключить инжекцию дырок из базы в коллектор благодаря образованию барьера для дырок, поэтому допустимо Nк 1017 см-3 при Nб 1019 см-3. Трехслойная n-р-n-структура с двумя гетеропереходами позволяет реализовать взаимозаменяемость эмиттера и коллектора в ИС и возможность оптимизировать параметры базы и коллектора.
Ожидается, что наибольшим быстродействием будут обладать БТ со структурой GaAGe – GaAs за счет того, что Ge – допускает сильное легирование акцепторными примесями и имеет высокую подвижность дырок, обеспечивая малое сопротивление базы.
Возможные конструкции гетероструктурных БТ (ГСБТ) приведены на рис.
Первая реализация ГСБТ (рис.5а) представляет двухслойную структуру: широкозонную GaAAs (вдоль поверхности) и под ней – узкозонную GaAs. Эмиттерный гомопереход в широкозонном приповерхностном слое пропускает ничтожно малый ток по сравнению с током через гетеропереход в узкозонную область, где высота барьера на ЕД меньше. Практически транзистор работает в вертикальном направлении при отключенной горизонтальной части.
Эти же идеи использованы для создания обращенного транзистора (узкий коллектор с малым Ск на поверхности) с одновременным сужением активной части эмиттера рис.5, б.
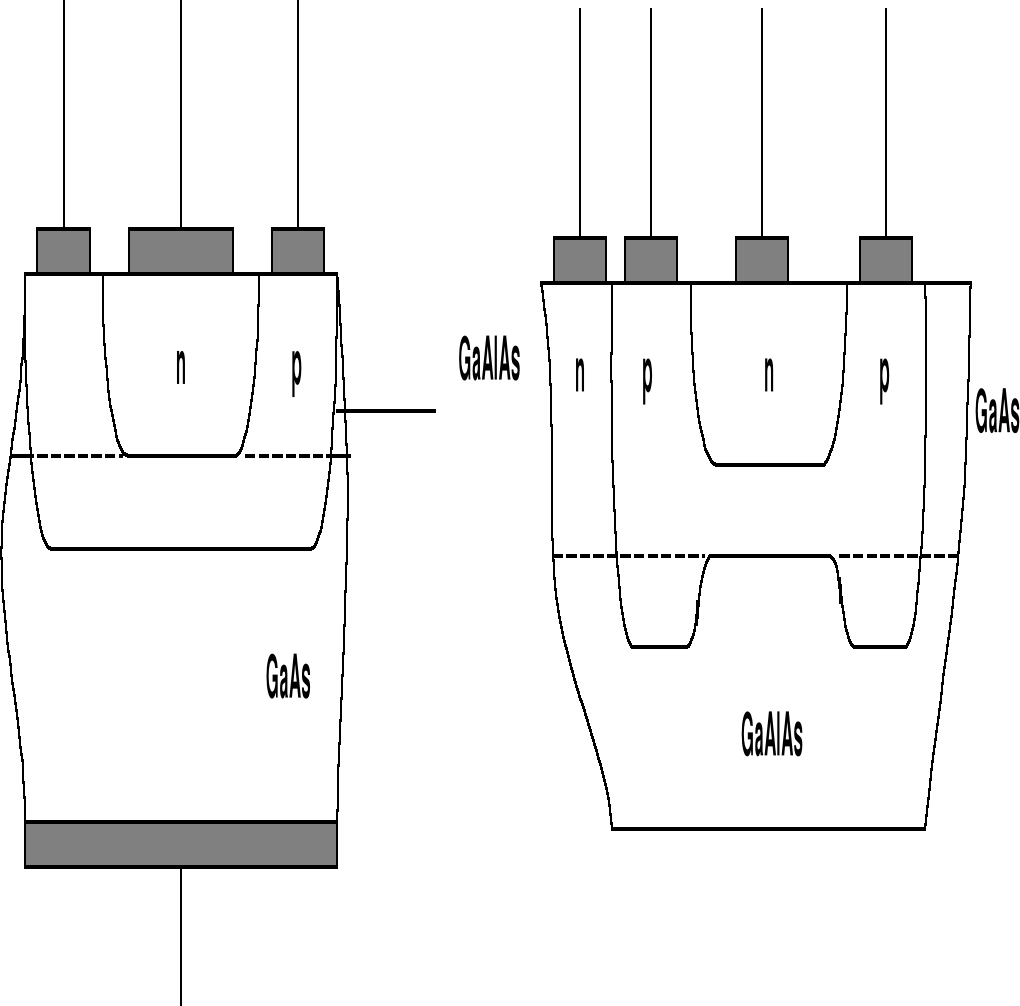
а б
Рис.5
Для таких структур с микронным эмиттером и электронной базой при I = 2 мА, Vл = 0,5 В получено Д = 8 nс, fт 29 ГГц, fмакс 19 ГГц, Рд = 1 мВт (время задержки при переключении).
Серьезные технологические трудности пока не позволяют использовать указанные структуры в БИС и СБИС (т.к. физика дефектообразования и ряд других процессов в материалах группы А3В5 существенно отличаются от аналогичных явлений в кремние (хотя отдельные образцы) гетеролазеры, гетерофототранзисторы) с широким эмиттером уже получены с удовлетворительными характеристиками.
Варизонные БТ (ВБТ). Благодаря возрастанию ширины запрещенной зоны от коллектора к эмиттеру в ВБТ n-р-n по всей структуре для неосновных носителей заряда имеется встроенное поле Евстр. Это поле, с одной стороны, ускоряет пролет инжектированных электронов через базу (как в дрейфовых БТ), а с другой – препятствует инжекции дырок из базы в эмиттер (как в плавном гетеропереходе). Эффект уменьшения времени задержки дрейфового пролета (б(Ев) dб/2Евстр = d2бq/2Ед) в варизонной структуре значительно превышает аналогичный эффект в дрейфовом транзисторе (в котором Евстр обусловлено неоднородным легированием базы и по порядку величины его произведение на толщину базы (dб) не превышает нескольких кТ/q ).
Рис.6
Так при Ед = 0,15 эВ, dб = 5105 см получаем Евстр = 5 кВ/см. При этом б при Nб = 1018 см-3 составит приблизительно 5 пс. Энергетическая диаграмма такой структуры приведена на рис.6.
2. Полевые СВЧ транзисторы