Проектирование фоточувствительных приборов с зарядовой связью с обратной засветкой в ОАО “НПП “Пульсар”
Введение.................................................................................................................2
1. Принцип работы ФПЗС (обзор литературы).............................................3
1.1 Организация фотоприемных СБИС на ПЗС..........................................3
1.2 Типы структур фотоприемных ячеек ФПЗС.......................................5
1.3. Генерация заряда в ФПЗС........................................................................6
1.4. Накопление заряда в пикселях ФПЗС.................................................10
1.5. Перенос и детектирование заряда........................................................10
2. Моделирование ФПЗС с обратной засветкой (основная часть).................
2.1. ФПМ и метод краевой функции рассеяния.............................
2.2. Пути решения............................................................................
2.3. 2D моделирование структуры....................................................
2.4. Теоретические модели ...............................................................
2.5. Технологическое моделирование .........................
2.6. Результаты моделирования.............................................
2.6.1. Построение КФР для различных вариантов подложек...............
2.6.2. Зависимость модуляции от параметров.................................
Выводы....................................................................................
3. Организационно - экономическая часть....................................
3.1. Аннотация........................................................................
3.2. Структура организации работ.................................
3.3. Бизнес-план.....................................................................
3.4. Расчет затрат и договорной цены.................................
3.5. Обоснование целесообразности разработки.................................
Выводы................................. .................................
Использованная литература................................. .................................
Приложение А................................. .................................
Введение
Приборы с зарядовой связью (ПЗС) были изобретены Виллардом С. Бойлом и Джорджем Е. Смитом в 1969 г. Зарядовая связь представляет собой возможность осуществлять аналоговую и цифровую обработку информации в виде зарядовых пакетов. Самая распространенная сфера применения ПЗС - фоточувствительные ПЗС (ФПЗС), преобразующие излучение в электрический сигнал.
Принцип работы ФПЗС основан на возникновении, хранении и направленной передаче зарядовых пакетов в потенциальных ямах, образующихся в приповерхностном слое полупроводника при приложении напряжений к электродам.
Существуют два способа засветки ПЗС: прямая (со стороны электродов) и обратная. При прямой засветке излучение проходит через электроды, подзатворный диэлектрик и затем поглощается в подложке. Часть излучения отражается или поглощается этими структурами, что ведет к уменьшению квантовой эффективности. Для увеличения квантовой эффективности производится засветка с обратной стороны, и излучение проникает сразу в кремний через антиотражающее покрытие. Но для реализации такой операции необходимо произвести утонение подложки для исключения рекомбинации носителей в объеме полупроводника. С процессом утонения связана дороговизна в связи со сложностью процесса.
Следующая особенность ФПЗС с обратной засветкой это уменьшение величины модуляции в связи с термогенерацией носителей заряда и диффузионным растеканием зарядового пакета. Путем подбора параметров можно избежать уменьшения величины модуляции.
Количественно оценить указанные процессы можно только с помощью приборно-технологического моделирования. Поэтому особенно важно при проектировании применять моделирование. Работа посвящена отработке методики моделирования значения модуляции выходного сигнала ФПЗС с обратной засветкой на базе коммерческого пакета приборно-технологического моделирования Sentaurus TCAD (Synopsys).
1. Принцип построения и работы ФПЗС
1.1 Организация фотоприемных СБИС на ПЗС
ФПЗС приемники подразделяются по типу организации на линейные (МДП-конденсаторы расположены последовательно в линию – однокоординатные ФПЗС) и матричные (двухкоординатные ФПЗС). В линейных ФПЗС получение изображения происходит в результате механического перемещения (сканирования) и их можно найти на борту самолета или другого движущегося устройства [1]. В свою очередь, матричные подразделяются на ФПЗС с кадровым и межстрочным переносом. ФПЗС с кадровым переносом образована совокупностью вертикальных регистров и имеет одну фоточувствительную область и выходной сдвиговый регистр с устройством вывода информации (рис.1.1.а). Такая матричная структура носит название полнокадровая и находит достаточное широкое применение при регистрации неподвижных или импульсных изображений. Преимуществом такой организации является достаточная простота конструкции, основной недостаток - необходимость механического затвора, перекрывающего световой поток на время считывания накопленного кадра. Если к фоточувствительной секции полнокадровой матрицы добавить секцию хранения, экранированную от света, то мы получим матрицу с кадровым переносом. (рис.1.1.б).
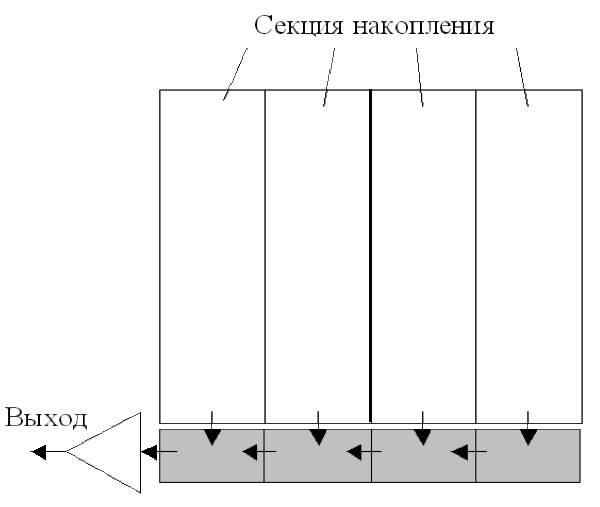
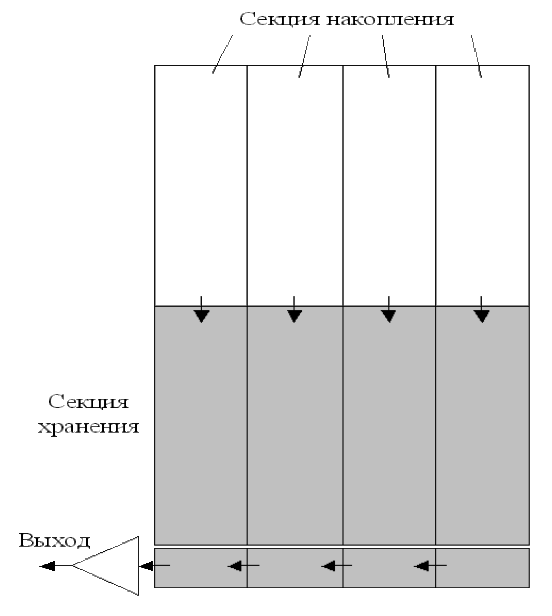
а) б)
Рис. 1.1. Конструкция матриц ФПЗС с переносом кадра
В процессе освещения секции накопления в ней происходит накопление зарядовых пакетов. По окончании времени накопления зарядовые пакеты за короткое время переносятся в секцию хранения, высвобождая таким образом секцию накопления от заряда. После этого цикл повторяется вновь с одновременным переносом в выходной регистр зарядовых пакетов предыдущего кадра из секции хранения.
Основным недостатком матриц с кадровым переносом является высокий смаз изображения, возникающий при переносе изображения из секции накопления в секцию хранения. Во время кадрового переноса секция накопления остаётся открытой для света и яркие участки изображения успевают дать вклад в чужой зарядовый пакет даже за то короткое время, когда он проходит через них и происходит смазывание изображения.
Проблема смаза изображения решается в ФПЗС с межстрочным переносом. В отличие от матриц с кадровым переносом, функции накопления заряда и его переноса здесь разделены. Матричная структура с межстрочным переносом (рис. 1.2.а) кроме фоточувствительных элементов содержит экранированные от света секции хранения, расположенные между столбцами. В отличие от матриц с кадровым переносом, где ПЗС ячейка выполняет поочерёдно функции накопления и переноса, матрицы с межстрочным переносом имеют пространственное разделение этих функций. ФПЗС с межстрочным переносом имеют сложную конструкцию ячейки и уменьшенную фоточувствительную площадь за счёт встроенных вертикальных каналов переноса, которые необходимо экранировать от света. В такой структуре перенос кадра из секции накопления в экранированные от света области хранения происходит за один такт, занимающий время не более 1 мкс. Ещё больше уменьшить смаз изображения позволяет конструкция ФПЗС со строчно-кадровым переносом, приведённая на рис.1.2.б. [2].
К недостаткам матриц с межстрочным переносом относится существенно меньшая площадь фоточувствительного элемента в сравнении с матрицами с переносом кадра.
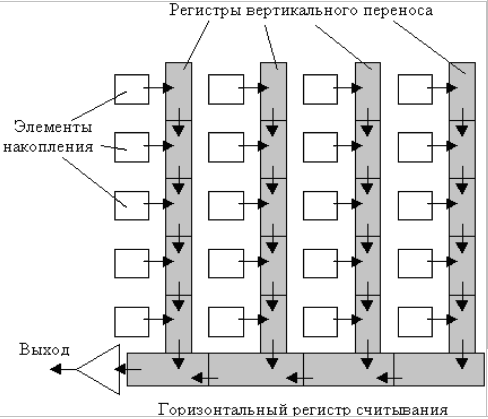
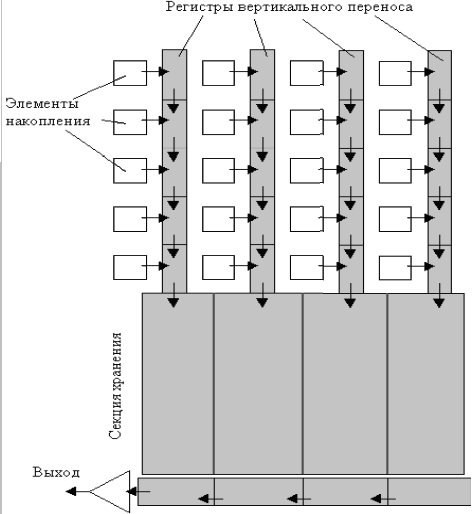
а) б)
Рис.1.2. Конструкция матриц ФПЗС с межстрочным переносом
1.2 Типы структур фотоприемных ячеек ФПЗС
В ПЗС с кадровым переносом генерация и перенос заряда происходят в одной и той же области фотоприемной ячейки. После освещения датчик должен быть экранирован от света для считывания зарядового пакета. На рис. 1.3 показан вид сверху и поперечное сечение фотоприемной ячейки полнокадровой матричной структуры. Размеры фотоприемных ячеек находятся в интервале значений от 24x24 мкм2 до 6x6 мкм2[3].
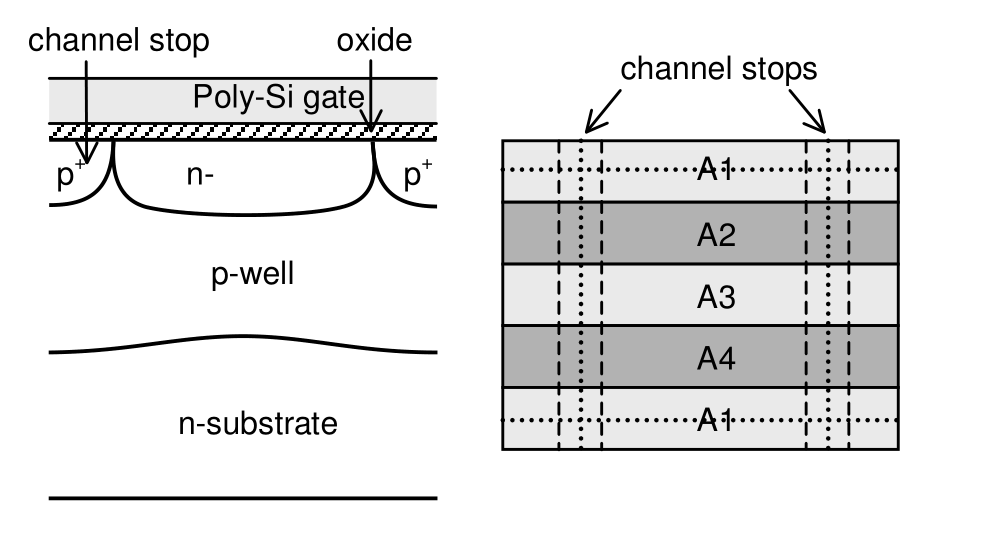
Рис. 1.3. Поперечное сечение ячейки полнокадрового ПЗС и вид сверху.
Со строением пикселя связано основное достоинство ФПЗС с переносом кадра: вся площадь секции накопления является фоточувствительной. Эта особенность выводит приборы с кадровым переносом на первое место везде, где требуется высокая чувствительность.
В ПЗС с межстрочным переносом каждый пиксель состоит из фотодиода и одной ячейки регистра ПЗС. После освещения, собранные электроны переносятся с фотодиода в регистры считывания. На рис. 1.4 показано сечение пикселя ПЗС с межстрочным переносом и прилегающей регистр считывания, где PD - фотодиод, TG - затвор перехода, CS - стоп канал, V-CCD - регистр считывания.
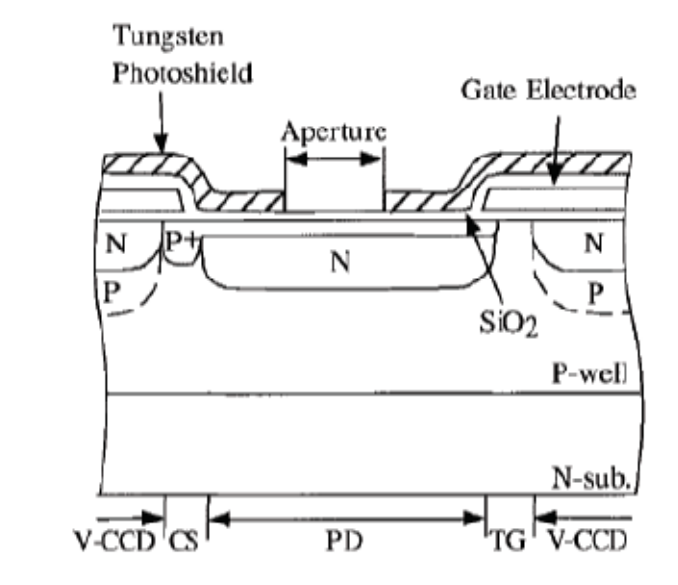
Рис.1.4. Сечение ячейки ПЗС с межстрочным переносом.
1.3. Генерация заряда в ФПЗС
При освещении ФПЗС поглощаемые в полупроводнике фотоны вызывают генерацию электронно-дырочных пар. В обедненном слое под действием электрического поля эти пары разделяются. Величина зарядового пакета, накапливаемая в данном элементе, пропорциональна усредненному по площади элемента потоку фотонов и времени накопления.
Эффективность генерации заряда в ПЗС определяется квантовой эффективностью , которая представляет собой долю падающего излучения, приводящая к появлению заряда. В идеальном ПЗС на всех длинах волн. Квантовая эффективность зависит от длины волны, заметно снижаясь при ИК и УФ длинах волн. Чувствительность ПЗС находится в интервале от 1.1 эВ до 10 КэВ ( 1000 - 0.1 нм ), куда входят ИК, видимый свет, УФ, экстремальный УФ и мягкий рентген. В диапазоне энергий от 1.1 до 3.1 эВ ( длины волн 1126 - 400 нм ) фотон генерирует одну электронно-дырочную пару. В этом диапазоне находится ближний ИК и видимый свет. Но не все фотоны порождают электронно-дырочные пары. Кремний является прозрачным для фотонов с энергией меньше 1.14 эВ, которые находятся в диапазоне далекого ИК. Среднее число электронно-дырочных пар, генерированных фотоном с энергией E , дается соотношением для квантового выхода

где - энергия, необходимая для создания электронно-дырочной пары. Фотоны с энергией более 3.1 эВ будут генерировать множество электронно-дырочных пар, но это не значит повышение квантовой эффективности. Это происходит в результате наличия коротковолновой границы. Коротковолновая граница (около 400 нм) обусловлена сильным поглощением коротковолновых квантов света в тонком приповерхностном слое, в котором одновременно с фотогенерацией носителей интенсивно происходит их рекомбинация.
Спектральная характеристика отражает способность ФПЗС матрицы преобразовывать оптическое излучение с различными длинами волн в электрический заряд. Применительно к ФПЗС матрицам спектральная характеристика представляет собой зависимость квантовой эффективности от длины волны.
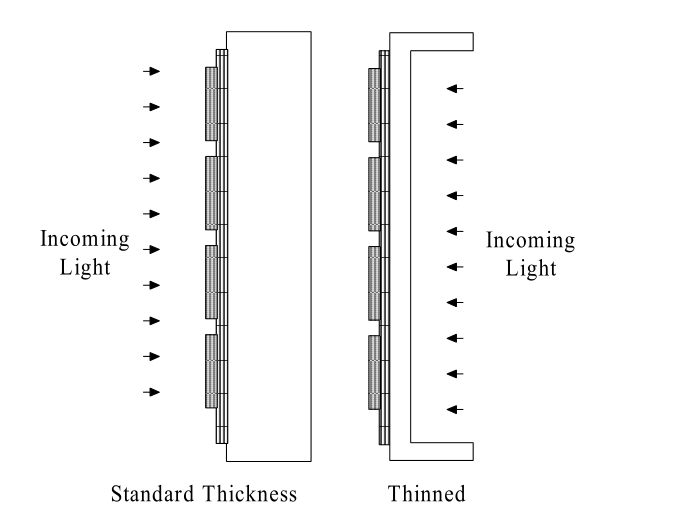
Рис.1.5. Типы засветки ПЗС.
Существуют два способа засветки ПЗС: прямая (со стороны электродов) и обратная (рис1.5). Прямая засветка характеризуется низким коэффициентом пропускания из-за непрозрачности электродов. Этот недостаток принципиально неустраним. Широко используемые в технологии ПЗС поликремневые электроды, хотя и являются полупрозрачными, плохо пропускают излучение синей области спектра. Вследствие интерференционных эффектов, возникающих в многослойной структуре, на спектральной характеристике появляются пики и провалы.
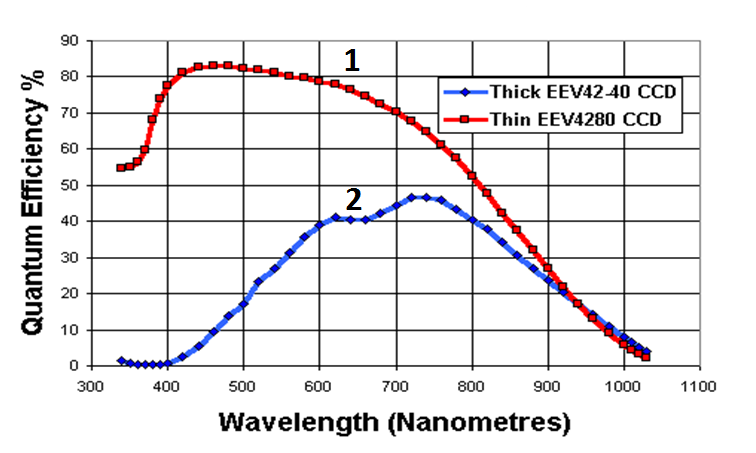
Рис. 1.6. Спектральная чувствительность ПЗС. 1 - ФПЗС матрица, освещаемая со стороны подложки; 2 - ФПЗС матрица, освещаемая со стороны электродов.
При обратной засветке излучение проходит через подложку, прозрачность и однородность которой значительно выше. Важной особенностью режима обратной засветки является сильное диффузионное расплывание зарядового пакета, так как расстояние, которое должны пройти заряды от зоны фотогенерации до обедненного слоя значительно больше, чем в режиме прямой засветки. Спектральная характеристика при этом имеет вид плавной кривой.
Высокоомные ПЗС с обратной засветкой (High-Resistance Silicon Substrate CCDs), как правило, имеют более высокую квантовую эффективность в более широком диапазоне длин волн, особенно в ближнем инфракрасном диапазоне, что делает их полезными для различных астрономических приложений. Эти устройства имеют большую толщину (200 ~ 300 мкм) и имеют большой темновой ток [6,9]. Для уменьшения темнового тока производится охлаждение до температур 140C [4]
Генерация в видимом диапазоне имеет максимум при 650 нм. На длинах волн короче 650 нм фотоны поглощаются затворной структурой. Квантовая эффективность падает всего на несколько процентов при 400 нм, но проблемы возникают на длинах волн ниже 300 нм. Для 250 нм глубина проникновения в кремнии уже только 30 , что есть только несколько атомных слоев. Чувствительность начинает возвращаться при длине волны 10 , что дает возможность использовать ФПЗС в качестве датчиков рентгеновского излучения [5,6].
Для увеличения чувствительности в области синего и УФ света наносят покрытие из фосфора на затворы, что было использовано в Hubble WF/PC II CCDs [7]. Фотон с длиной волны короче 460 нм поглощается поверхностью, которая реэмитирует другой фотон на длине волны 520 нм, для которой ПЗС имеет большую чувствительность. Правда половина реэмитируемых электронов покидает поверхность, минуя поглощение. Покрытия из фосфора это дешевый способ увеличить чувствительность в УФ диапазоне. Лучший, но более дорогой способ это обратная засветка, при которой излучение падает на заднюю часть структуры без электродов. Но необходимо иметь тонкую подложку, поскольку заряд генерируется в приповерхностном слое. Толщина подложки может достигать 10 мкм [8]. Утонение подложки это сложный процесс и много чипов уничтожаются при этом процессе. Следующая проблема, связанная с потерей квантовой эффективности, это отражение. На длине волны 400 нм от кремния отражается половина падающего света. Но этого можно избежать, если использовать антиотражающие покрытия. Пример антиотражающего покрытия это сплав оксида индия-олова, которое увеличивает проводимость освещаемой стороны, и слой SiO2 [9].
1.4. Накопление заряда в ячейках ФПЗС
В идеальном случае электроны накапливаются в фотоприемной ячейке без попадания в соседние. Диффузия в соседние ячейки приводит к смазыванию изображения. Причиной накопления заряда в неосвещенных фотоприемных ячейках является наличие квазинеитральной области (КНО) в кремнии. Электроны, генерированные в области слабого электрического поля вдали от электродов, имеют высокую вероятность продиффундировать в соседнюю ячейку. Для ФПЗС с прямой засветкой эта проблема является важной для излучения близкого ИК, поскольку длинноволновые фотоны проникают в подложку глубже, чем фотоны видимого диапазона. Для ФПЗС с обратной засветкой также происходит утечка в результате наличия КНО у освещаемой поверхности. С помощью тщательной конструкции (подбора управляющих напряжений и других параметров) и обработки взаимопроникновение можно уменьшить до приемлемых величин.
Второй причиной накопления заряда в неосвещенных ячейках является термическая генерация подвижных носителей заряда в обедненном слое. Такие подвижные носители заряда образуют темновой ток. Устраняется охлаждением подложки до низких иемператур, например - 45 [10]. Так же устранение темнового тока возможно при уменьшении дефектов при производстве ФПЗС с обратной засветкой [11].
Процесс накопления фотоэлектронов занимает определенное время, называемое периодом накопления. После этого происходит перенос накопленных зарядовых пакетов к выходному устройству, преобразующему заряд каждой ячейки в напряжение. Это напряжение, сложенное с кадровыми и строчными синхроимпульсами, представляет собой электрический композитный видеосигнал. В свою очередь, видеосигнал несет информацию об изображении, принятом ФПЗС приемником.
1.5. Перенос и детектирование заряда
Для того, чтобы считать накопленный заряд фотоэлектронов с каждого МДП- конденсатора, используется механизм переноса заряда из одной фоточувствительной ячейки в другую с использованием дополнительных ячеек – регистров переноса. На одну ячейку приходится три затвора. Во время накопления заряда на регистры подается напряжения и заряд накапливается в пикселях. Регистры разделены стоп каналами, которые предотвращают распространение заряда между дорожками. Изображение считывается каналами переноса. Далее заряд переносится в усилитель и там заряд с каждой ячейки переводится в напряжение.
На рис.1.7 показан процесс переноса заряда в трехфазовом регистре. Во время t1 подано напряжение на фазу-1, формирующее потенциальную яму для заряда. Электроны, генерированные в фазах-2 и -3 продиффундируют в фазу-1. Во время t2 происходит перенос заряда из-за создания потенциальной ямы и барьеров при подаче напряжения на соответствующие затворы. Далее, напряжение на фазе-2 увеличивается и формируется потенциальная яма под ней. Теперь заряд разделен между двумя фазами. Потенциальный барьер между пикселями находится под фазой-3. Во время t3 фаза-1 заземляется и заряд переходит под фазу-2. За время t4 заряд перетекает из фазы-2 в фазу-3. Этот процесс будет продолжаться, пока весь пиксель не достигнет выходного усилителя.
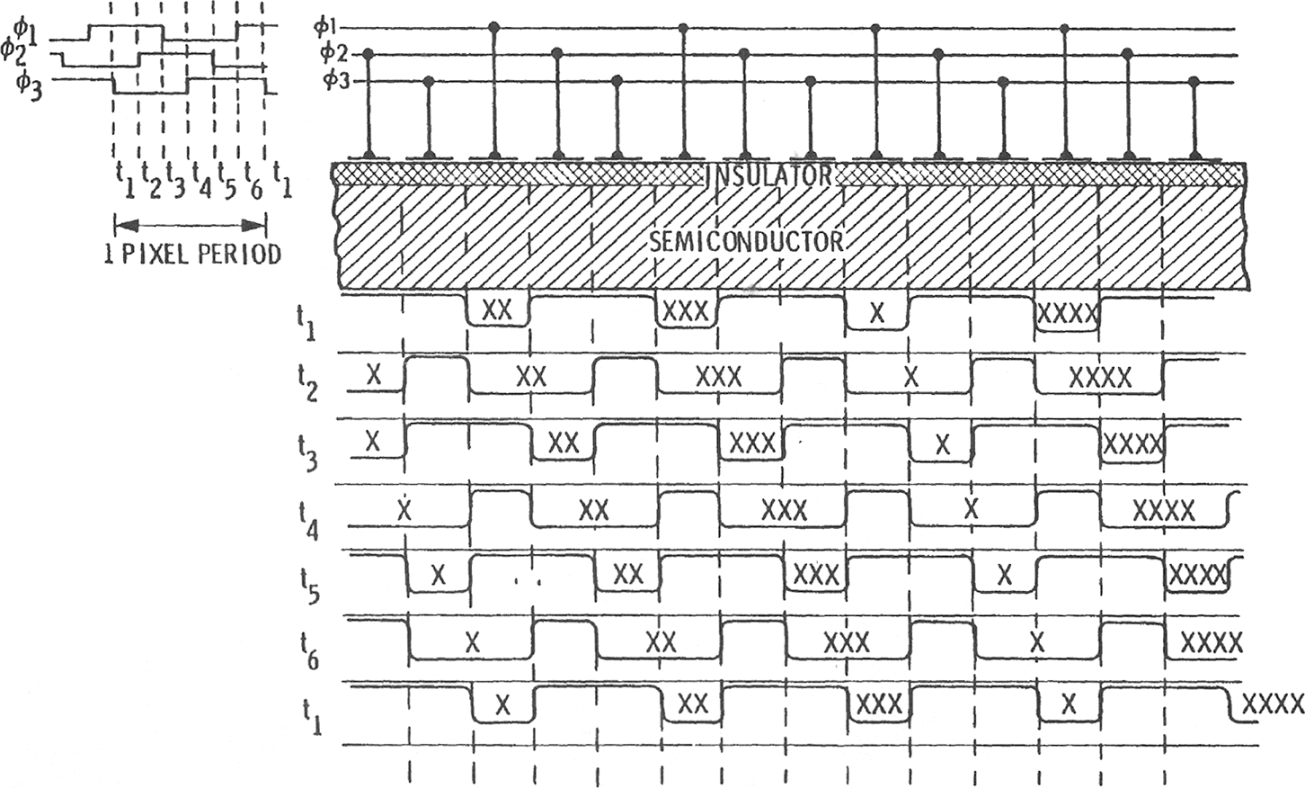
Рис. 1.7. Диаграмма переноса заряда.
В процессе переноса важно терять как можно меньшую часть передаваемого заряда. Например, фотометрическая точность для Hubble WF/PC II меньше 1% [12]. Это значит, что больше чем 99% заряда из пикселей выживает в результате процесса переноса и достигает выходного усилителя. Для края чипа, самого дальнего от усилителя, это значит выживание через 1600 переносов пикселей. Это ставит огромные требования для эффективности переноса заряда.
Первый ПЗС, произведенный в Bell Laboratories имел эффективность переноса из одного пикселя в другой около 99%. Но потери суммируются при увеличении числа переносов между пикселями. В данном случае, после 100 переносов только 63% заряда не будет потеряно. На данный момент величина эффективности переноса заряда достигает значения 99.9995%, что означает потерю одного электрона из миллиона при переносе [12].
Понимание причины потери заряда при переносе позволит увеличить эффективность переноса заряда. Перенос заряда включает в себя такие эффекты, как термическую диффузию и самоиндуцированный дрейф. Они играют роль при высокой скорости переноса заряда, поскольку термическая диффузия и самоиндуцированный дрейф не позволяют зарядовому пакету полностью перейти между фазами за короткий промежуток времени. Так же препятствует достижению 100% эффективности наличие ловушек в фотоприемных ячейках. Ловушки, представляющие из себя примеси или дефекты кристаллической решетки, захватывают часть заряда при переносе. Ловушки могут появляться в процессе производства и технологических операциях. Также появление ловушек связано с повреждением кремния при бомбардировке протонами, электронами, нейтронами, тяжелыми ионами и гамма квантами. Эта проблема наиболее выражена для ПЗС, находящихся в космосе. Даже единственная ловушка может иметь серьезные последствия для нормальной работы прибора. Ловушки можно устранять и в современных приборах существуют лишь несколько пикселей с ловушками, которые захватывают сотню электронов из зарядового пакетах [ ].
Последняя важная операция происходящая в процессе преобразования изображения в ФПЗС это детектирование и измерение накопленного заряда. Это осуществляется попаданием заряда в конденсатор, соединенный с выходным MOSFET усилителем [1]. Выходной усилитель генерирует напряжение для каждого пикселя пропорционально зарядовому пакету. Разработчики ФПЗС работают над уменьшением выходной емкости. Чем она меньше, тем больше усилительный шум и выше выходной сигнал.
При увеличении чувствительности необходимо следить за тем, чтобы шум оставался на низком уровне. Уменьшение шума ведет к увеличению чувствительности ФПЗС. Хотя есть много нежелательных источников шума, все может быть сведено к нулю. Единственный источник шума, который не может быть полностью устранен, происходит из выходного усилителя. Шум создается случайными флуктуациями в токе, текущем через транзистор. Ранние ПЗС имели уровень шума около 30 rms при измерении сигнала с каждого пикселя. На данный момент высокопроизводительные ПЗС имеют уровень шума ниже 2 rms [ ].
2. Моделирование ФПЗС с обратной засветкой
2.1. ФПМ и метод краевой функции рассеяния
Изображающие приборы могут давать изображение различного качества с точки зрения передачи структуры предмета. Структура и форма светового поля в пространстве изображений подобна структуре и форме предмета, однако оптическая система вносит в эту структуру свои изменения, оценка которых есть оценка качества изображения. Передача структуры предмета или изображения – это отображение оптической системой мелких деталей объекта.
Показатель качества ПЗС это его разрешающая способность. Разрешающая способность определяет способность оптической системы изображать раздельно два близко расположенных точечных предмета. Предельная разрешающая способность – это минимальное расстояние между двумя точками, при котором их изображение отличимо от изображения одной точки.
Разрешающая способность, как параметр, определяется при указании значения контраста при котором достигнуто заявленное разрешение. Контраст изображения характеризует нормированное отношение яркостей самой темной и самой светлой детали изображения. Контраст вычисляют, используя выражение:
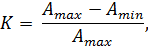
а модуляцию:
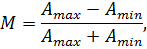
Где Amax, Amin – максимальная и минимальная яркость.
Таким образом, модуляция связана с контрастом выражением:

Для измерения разрешающей способности видеокамер во всем диапазоне контрастов используют функцию передачи модуляции (ФПМ), представляющую собой зависимость модуляции от пространственной частоты. Основная задача изображающего устройства заключается в преобразовании освещенности предмета в видеосигнал и передачу его в виде изображения максимально высокого качества. Но фоточувствительные матрицы привносят в сигнал искажение, что является препятствием для получения идеального изображения.
Для улучшения качества изображения необходимо осуществлять контроль и устранять причины ухудшения изображения. Такой контроль представляет из себя испытания, заключающимся в том, что производится измерение контраста штрихов на тест-таблице, называемой мирой, и сравнивают их с контрастом изображения миры, полученным с помощью тестируемого прибора. В идеале этот контраст не должен отличаться. В реальности прибор существенно изменяет контраст изображения, и чем уже ширина штрихов на мире, тем эти изменения существенней.
На рис.2.1 изображена мира. Контраст черных и белых полос на всех тест-таблицах одинаков и близок к максимуму. Когда изображающее устройство начинает формировать изображение миры, то у них возникают трудности, связанные с сохранением исходного контраста полос на полученном изображении миры. Хорошо видно, что чем уже вертикальные полосы, тем меньше их контраст на экране монитора.
Исходя из этого примера, можно сделать следующие заключения:
1. Первый признак недостаточной разрешающей способности прибора это снижение контраста мелких элементов изображения.
2. Чем меньше элемент изображения тем больше должна быть разрешающая способность прибора.

Рис. 2.1. Мира.
Для количественной оценки разрешающей способности видеокамер существуют три значения: уровень модуляции 10% показывает предельную разрешающую способность видеокамеры; уровень модуляции 50% показывает реальную разрешающую способность и предназначен для сравнения видеокамер; уровень модуляции 30% – пороговая разрешающая способность. Именно она ограничивает минимальные значения модуляции предметов, находящихся перед объективом видеокамеры, которую можно использовать в качестве исходных данных при проектировании.
В данной работе определяется модуляция выходного сигнала ФПЗС с помощью миры, представляющей из себя чередующиеся полосы света, при заданном пространственном разрешении (рис.2.2). Пространственное разрешение ФПЗС определяется по формуле

где Тпр - пространственный период тестового изображения. Определение модуляции возможно без точного позиционирования миры при Тпр = 4Lфпя, где Lфпя - размер фотоприемной ячейки. При таком пространственном периоде будут полностью освещенные и полностью темные фотоприемные ячейки ФПЗС (ФПЯ на рис.2.2). Расчет модуляции производится по формуле:
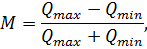
где и максимальная и минимальная величина заряда, находящегося в фотоприемных ячейках на рис 2.2. Минимальный заряд будет находиться в темной области, а максимальный будет находиться в освещенной области. В идеальном случае заряд не будет накапливаться в неосвещенных ячейках и , а следовательно Но в реальности величина модуляции не достигает 100%. Причиной является накопление заряда в неосвещенных ячейках и это является основной проблемой ФПЗС с обратной засветкой. Накопление заряда в неосвещенных ячейках происходит по двум причинам :
- Термическая генерация подвижных носителей заряда в обедненном слое.
- Диффузионное растекание носителей, фотогенерированных в квазинеитральной области (КНО) подложки.
Устранение термической генерации возможно при охлаждении подложки, а подбором величин управляющих напряжений ширина КНО может быть минимизирована и в наименьшей степени КНО будет влиять на характеристику изображения. Количественно оценить указанные процессы можно только с помощью приборно-технологического моделирования.
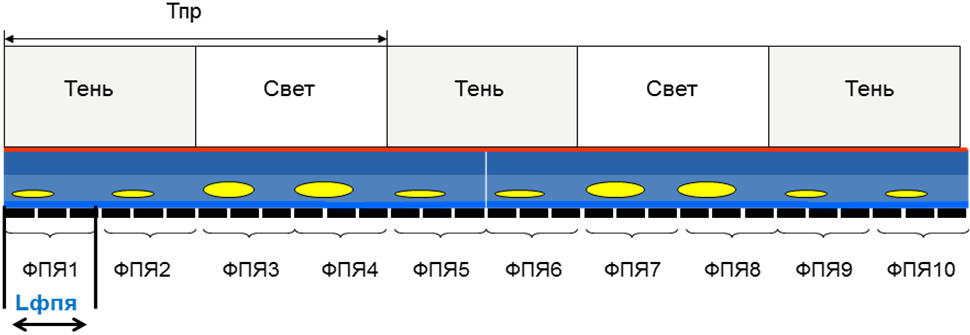
Рис.2.2. Схема процесса определения модуляции выходного сигнала.
Для получения величины модуляции в зависимости от пространственного разрешения, то есть ФПМ, необходимо использовать метод краевой функции рассеяния. Этот метод был отработан с помощью приборно-технологического моделирования.
Для получения ФПМ для начала необходимо получить краевую функцию рассеяния (КФР), представляющая из себя зависимость величин фотогенерированных зарядов в фотоприемных ячейках ФПЗС от положения миры (рис.2.3.б).
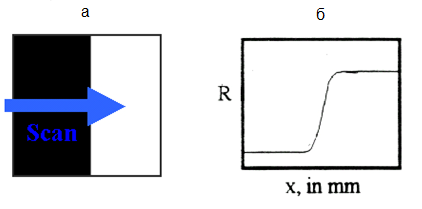
Рис.2.3. Изображение (а) и краевая функция рассеяния (б).
Получение КФР предполагает сканирование изображения при освещении перпендикулярно поверхности. КФР дает хорошее описание перехода от освещенного участка к неосвещенному. Можно видеть, что такой переход не является мгновенным, как в идеальных приборах, а представляет собой плавный переход от темного к светлому. Причиной размытия перехода является диффузия.
Следующий шаг это взятие производной от КФР. Результатом взятия производной будет функция линии рассеяния (ФЛР) (Рис.2.4.а).
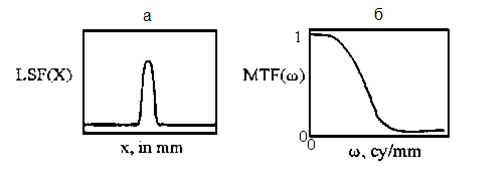
Рис.2.4. Функция линии рассеяния (а) и функция передачи модуляции (б)
ФЛР представляет собой степень размытия края полученного изображения. При стремлении системы к идеальной ФЛР будет стремиться к дельта-функции. После Фурье преобразования ФЛР получим ФПМ. Идеальная ФПМ должна во всем диапазоне разрешений иметь максимальный контраст близкий к единице, т.е. не искажать контраст исходного объекта. Но в действительности такого не происходит. На графике (Рис.2.4.б) видим, что на низких частотах затухание мало, но быстро увеличивается при увеличении частоты.
2.2. Пути решения
Цель работы представляет собой разработку методики моделирования технологического процесса и фотоэлектрических характеристик ФПЗС с обратной засветкой. В процессе работы определяются оптимальные конструктивно-технологических параметры подложки ФПЗС и величины управляющих воздействий на основе результатов моделирования величины модуляции сигнала фотоприемной ПЗС-ячейки.
Решаемая задача состоит в отработке методики практического моделирования значения модуляции выходного сигнала ФПЗС с обратной засветкой на базе коммерческого пакета приборно-технологического моделирования Sentaurus TCAD (Synopsys). Отработка методики состоит в разработке этапов проектирования для оптимизации структуры и получения численной модели, дающей реальные параметры техпроцесса.
Средства решения: двумерное приборно-технологическое моделирование с помощью программного комплекса SENTAURUS TCAD (Synopsys)
2.3. 2D моделирование структуры
Двумерное моделирование проводилось с помощью следующих программ комплекса SENTAURUS TCAD:
-программа технологического моделирования Sentaurus Process
-программа создания структуры Sentaurus Structure Editor (SSE),
- программа создания сетки Sentaurus Mesh (SMesh),
-программа моделирования физических процессов Sentaurus Device (SDevice),
-программа визуализации результата моделирования Tecplot SV.
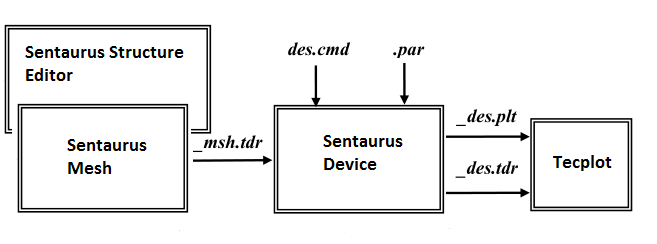
Рис. 2.5. Блок-схема последовательности моделирования и файлового окружения программ
Основной частью работы был процесс разработки методики оптимизации структуры для получения необходимых параметров приборов. В качестве методики выделены этапы приборно-технологического проектирования, представленные на рис.2.6.
Из реального технологического процесса изготовления экспериментального образца берутся параметры техпроцесса и применяются для численного моделирования техпроцесса в программе Sentaurus Process. Численное моделирование с использованием связки программ Sentaurus Process - SMesh - SDevice может занимать большое количество времени для одной структуры и не подходит для перебора различных параметров структуры (сопротивления и толщины подложки, управляющие напряжения и т.д.) для определения оптимального значения параметров прибора для максимализации модуляции выходного сигнала.
Для этих целей создается макет, представляющий собой аналитическое приближение профилей численно рассчитанной структуры. Макет строится с упрощением структуры и заданием грубой расчетной сетки.
С помощью макета возможна быстрая оптимизация структуры, состоящая в переборе различных параметров прибора для максимализации величины модуляции выходного сигнала.
В дальнейшем применение полученных параметров находит в численном моделировании, дающем реальные параметры техпроцесса.

Рис. 2.6. Этапы проектирования
При моделировании была получена зависимость модуляции от температуры и времени накопления и связь модуляции с реальными параметрами техпроцесса.
2.4. Теоретические модели
Диффузионно-дрейфовая модель используется для моделирования переноса носителей в полупроводниках при небольших отклонениях от термодинамического равновесия и при достаточно больших размерах структуры. Решение уравнения Пуассона дает распределение электростатического потенциала. Уравнение Пуассона дается выражением:

где:
- диэлектрическая проницаемость,
- элементарный заряд электрона,
являются концентрациями электронов и дырок соответственно,
- концентрация ионизированных доноров,
- концентрация ионизированных акцепторов,
- является плотностью заряда ловушек .
Наряду с уравнением Пуассона решаются уравнения непрерывности:


где:
- темп рекомбинации-генерации,
- плотность электронного тока,
- плотность дырочного тока.
Плотности токов согласно диффузионно-дрейфовая модели имеют вид:


- коэффициенты диффузии электронов и дырок,
- подвижности электронов и дырок,
E - напряженность электрического поля.
В расчете был использован механизм рекомбинации-генерации Шокли-Рида-Холла:

где концентрация равновесных электронов (дырок) в собственном полупроводнике.
характеристические времена, определяемые коэффициентами захвата неравновесных электронов и дырок ловушками с концентрацией Nt .
Поглощение оптического пучка в среде Sentaurus Device происходит по закону Бугера-Ламберта-Бера:

- интенсивность входящего пучка,
тольщина слоя вещества,
показатель поглощения.
Модель поглощения оптического пучка использует выражение для генерации:

где t - время,
функция изменения пучка со временем.
z0 - координата поверхности полупроводника,
неоднородный коэффициент поглощения по оси z.
2.5. Технологическое моделирование
Для получения профиля примеси необходимо провести численное моделирование технологических процессов с помощью Sentaurus Process на основе данных из реального технологического процесса изготовления экспериментального образца.
Технологический процесс состоит из основных этапов:
- Рост оксида.
- Осаждение нитрида.
- Ионная имплантация примеси.
- Диффузия примеси.
- Осаждение поликремния.
В результате проведения численного моделирования были получены одномерные профили примеси, по которым строились макеты. Код процесса в приложении А. На основе профилей примеси, полученных при технологическом моделировании строятся макеты профилей примеси.
2.6. Результаты моделирования
2.6.1. Построение КФР для прямой и обратной засветки
В данном пункте показан процесс построения КФР. На рис 2.8. приведены двумерные распределения концентраций электронов для сечения матрицы в направлении строк для длины волны входного излучения 535 нм. На рис.2.7. приведена схема расположения двумерных распределений с учетом времени засветки. Длина элемента вдоль строки – 12 мкм. Засветка матрицы производится с обратной стороны утонченной до 30 мкм подложки. Представленные результаты впервые на практике демонстрируют возможность построения КФР с помощью двумерного приборно-технологического моделирования. Приведены распределения электронов для фотоприемной матрицы при обратной и фронтальной засветке, использованные для построения краевой функции рассеяния. Результаты демонстрируют преимущества фронтальной засветки при не полностью обедненной подложке. Профили легирующей примеси построены с помощью двумерного технологического моделирования.
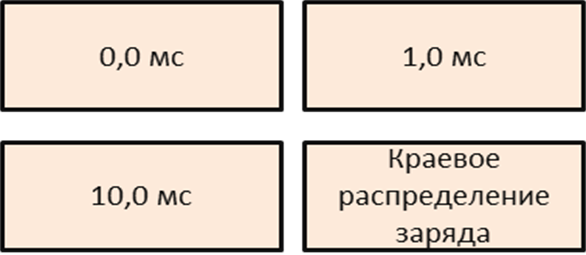
Рис 2.7. Схема расположения изображений двумерных распределений концентраций электронов

а)
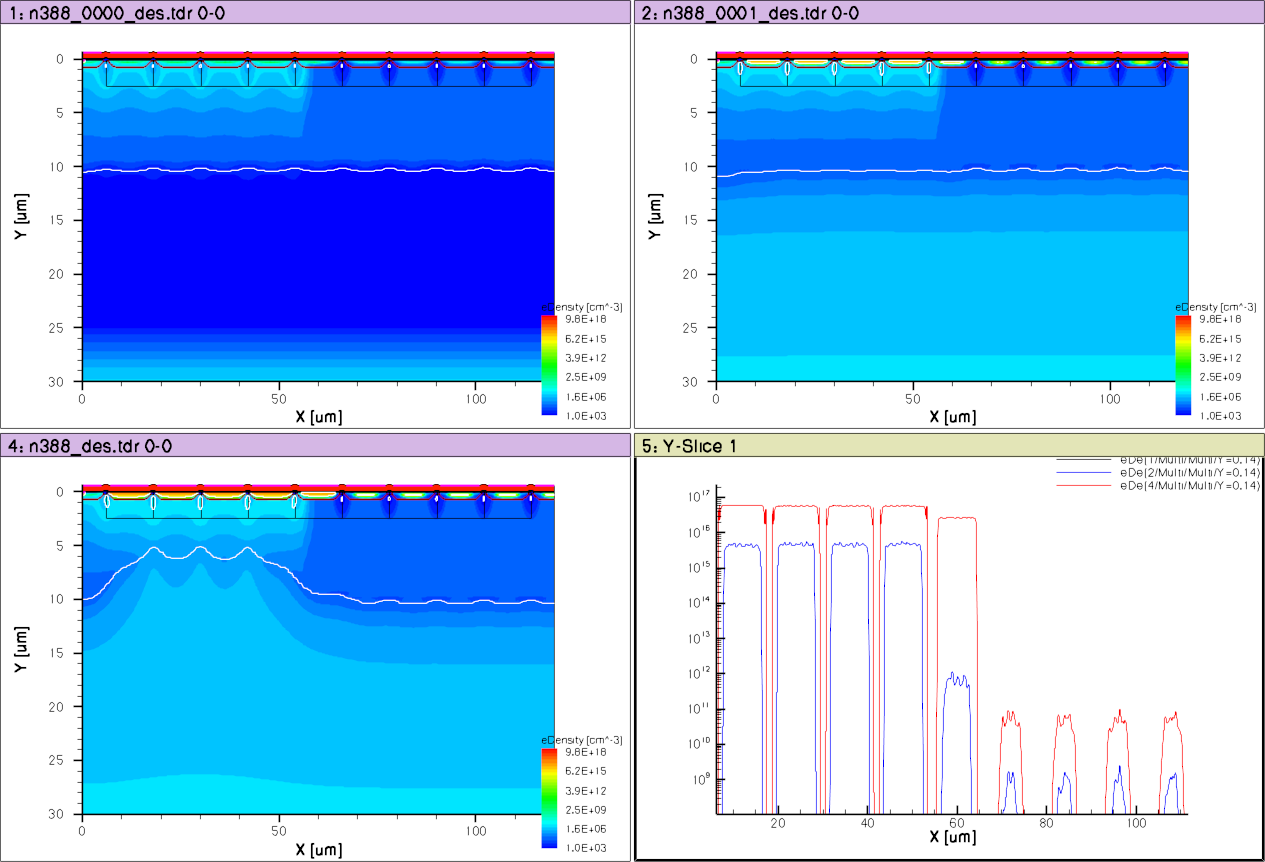
б)
Рис. 2.8. Распределение фотогенерированных носителей заряда для ПЗС с обратной (а) и прямой (б) засветкой. Длина волны 535 нм.
2.6.2. Модуляция и температуры подложек
На рис.2.9 представлены изображения двухмерных распределений плотностей электронов в подложке ПЗС в момент окончания стадии накопления (10 миллисекунд). Данная структура освещается со стороны подложки. Длина волны входного излучения: 900 нм.
Они наглядно демонстрируют влияние термогенерации и диффузии на модуляцию в зависимости от температуры. КНО ограничена белой линией около освещаемой поверхности. При низких температурах расплывание в результате диффузии в КНО и термогенерация в ОПЗ малы. Величина модуляции для охлажденной подложки равна M = 86%, что является достаточно высоким значением. Величина модуляции для подложки при комнатной температуре M < 0.1%, что является очень низким значением и нормальная работа прибора при таких температурах с заданными параметрами структуры невозможна. Такие изображения получены для всех рассмотренных значений толщин подложек, диапазонов температур и управляющих напряжений.
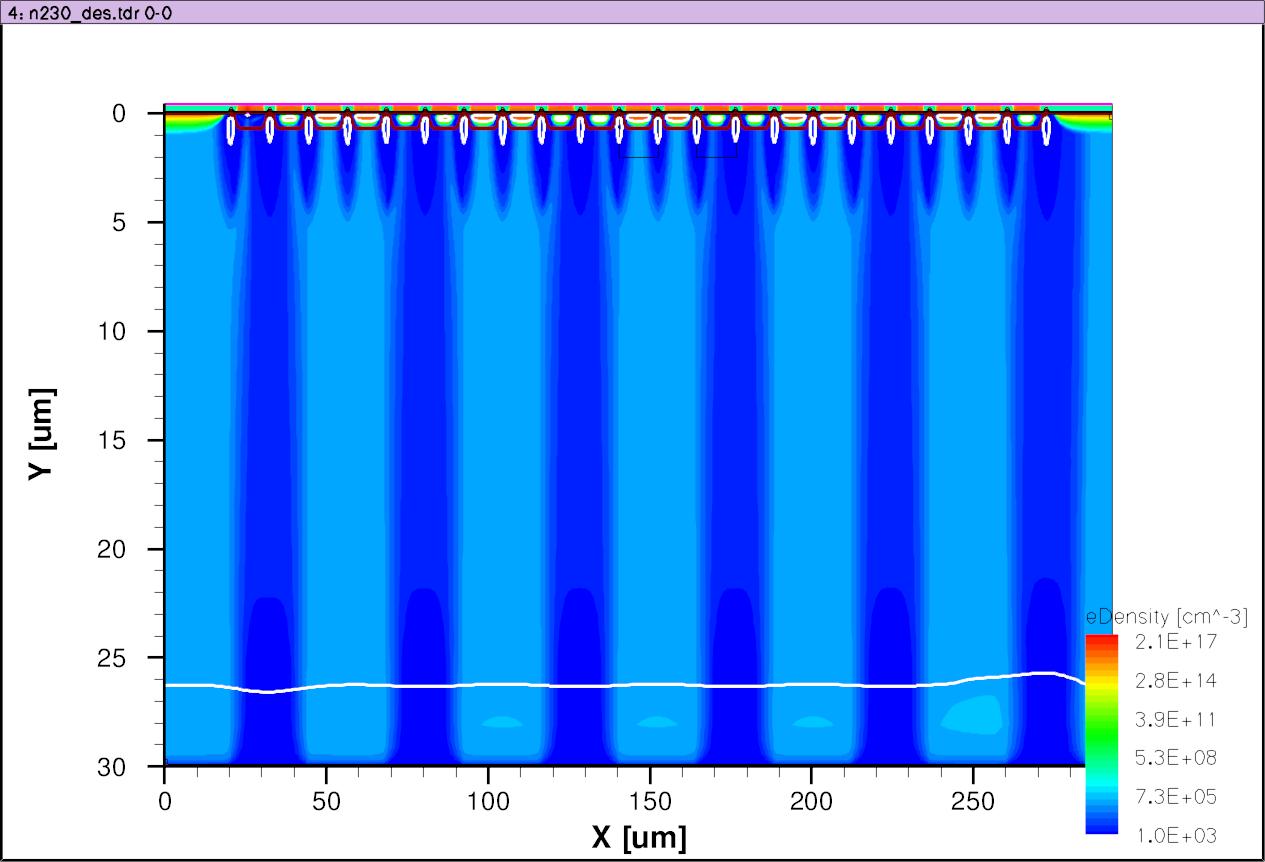
а)

б)
Рис.2.9. Двухмерные распределения плотностей электронов в подложке ПЗС охлажденной до -20оС (a) и при комнатной температуре (б).
На рис.2.10 приведена зависимость глубины модуляции от температуры для подложки толщиной в 30 мкм, удельным сопротивлением 100 Ом*см. Величина напряжения на затворе Vg = 8В.
При приближении к комнатной температуре глубина модуляции заметно падает и это приводит к необходимости охлаждения подложки ниже 270 К для получения глубины модуляции более 80%.
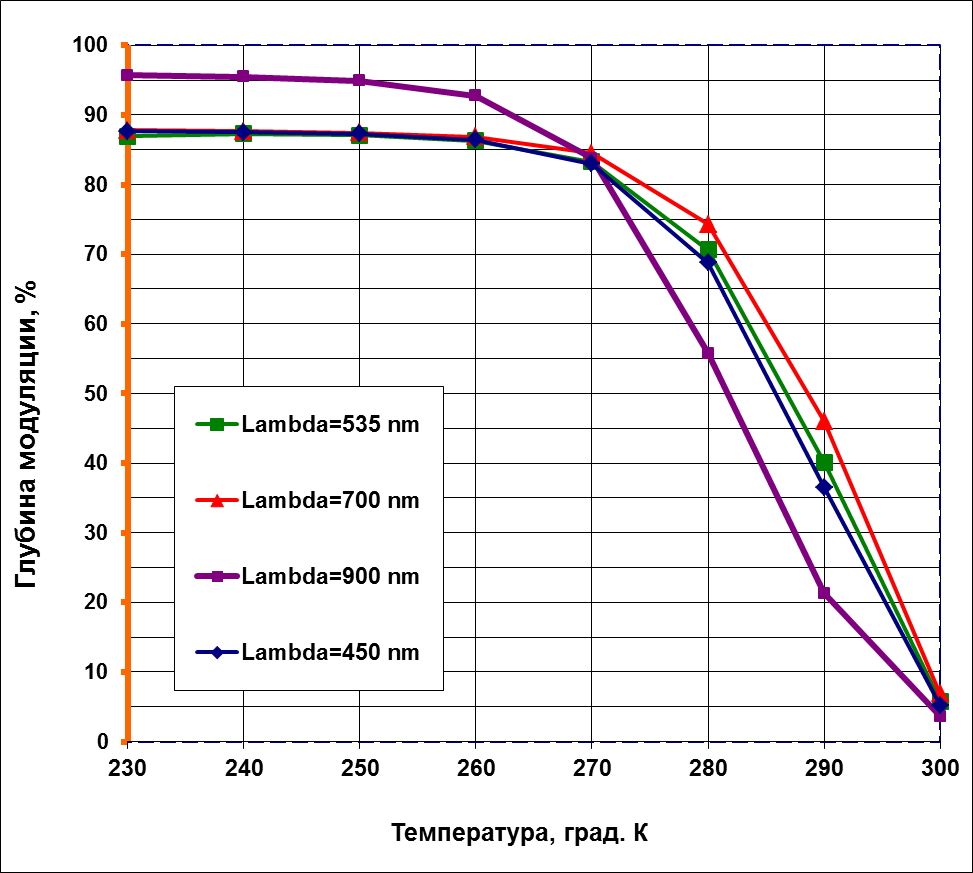
Рис. 2.10. Зависимость глубины модуляции от температуры ПЗС с обратной засветкой.
На рис.2.11 приведена зависимость глубины модуляции от толщины подложки при температуре -20 С. График построен по результатам всех численных экспериментов. При заданных характеристиках толщина подложки должны быть менее 30 мкм.
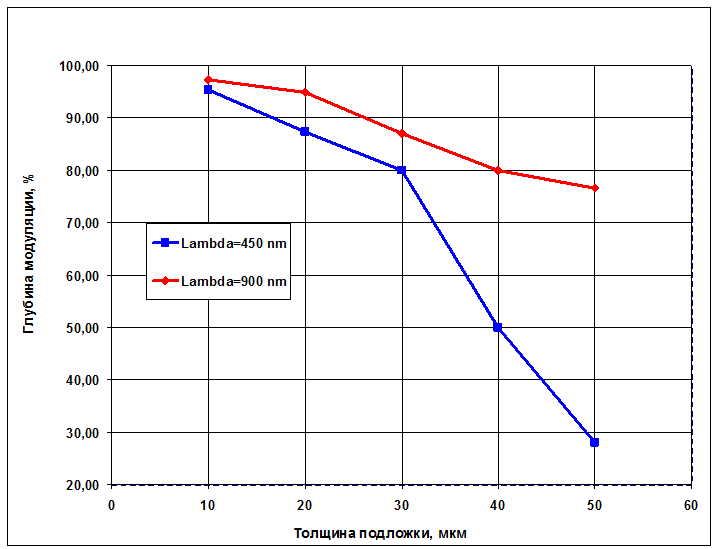
Рис.2.11. Зависимость глубины модуляции от толщины подложки при температуре -20 С.
Выводы
Отработана методика оценки величины модуляции сигнала ФПЗС от температуры с учетом реальной объемной структуры фотоприемных пикселов с помощью двумерного приборно-технологического моделирования (TCAD Synopsys)
Получены зависимости модуляции выходного сигнала от температуры и толщины подложки для:
- диапазона температур 230-300 К
- толщины подложек 15, 30, 50, 120 мкм
- удельные сопротивления подложек 50, 100, 1000, 2000 Ом*см
Определен рабочий диапазон температур ( ниже -20 С ) и предпочтительные толщины подложки ( менее 30 мкм) при удельном сопротивлении подложки в пределах 100-1000 Ом*см
Новизна данной работы состоит в том, что с помощью средств двумерного приборно-технологического моделирования (TCAD Synopsys) решена задача оценки величины модуляции сигнала ФПЗС от температуры с учетом реальной объемной структуры фотоприемных пикселов.
Результаты работы применены в процессе проектирования ФПЗС "ОПТРОН-6" на предприятии ОАО "НПП ПУЛЬСАР"
3.Организационно - экономическая часть
3.1 Аннотация
В рамках выпускной квалификационной работы разработана методика моделирования матричных фоточувствительных приборов с зарядовой связью (ФПЗС) с обратной засветкой. ФПЗС с обратной засветкой находят применение в космических исследованиях. Необходимость разработки методики моделирования возникает для оптимизации модели структуры в процессе производства ФПЗС. Данная работа проводилась в “Центре проектирования интегральных схем, устройство микро- и наноэлектроники” МГТУ МИРЭА и ОАО “НПП “Пульсар”. В данной части дипломной работы решаются проблемы планирования и организации работ, расчет договорной цены и экономическая целесообразность проекта.
3.2 Структура организации работ
В состав рабочей группы по проведению научно-исследовательской работы входят:
- Начальник центра проектирования (ЦП) (научный руководитель);
- Старший научный сотрудник ОАО “НПП “Пульсар” (консультант);
- Дипломник (разработчик);
Участие руководителя в работе состоит в консультации дипломника, проверке и утверждению выполненных этапов работы, а также согласовывает со старшим научным сотрудником последовательность и тип выполняемых исследований.
Старший научный сотрудник (консультант) предоставляет дипломнику необходимую специализированную литературу, а также информацию по исследуемой НИР и используемому программному обеспечению, контролирует выполнение дипломником исследовательской работы в соответствии с намеченным планом работ и вносит необходимые корректировки.
Дипломник (разработчик) изучает специализированную литературу, выполняет анализ исходных данных, проводит необходимые исследования и анализирует их, согласовывает полученные результаты консультантом и руководителем и проводит их оформление в виде пояснительной записки.
Этапы разработки
1.Техническое задание (ТЗ) [4 дня];
2. Техническое предложение(ТП) [6 дней];
3. Сбор и анализ существующей информации [13 дней];
4. Численное моделирование [27 дней];
5. Построение аналитического макета [34 дня];
6. Оптимизация структуры с помощью макетов [15 дней];
7. Численное моделирование после оптимизации [7 дней];
8. Контроль результатов [7 дней];
9. Итоговая презентация результатов [3 дня];
10. Подготовка документации и сдача темы [3 дня].
График работ
Наименования видов работ, должности исполнителей, трудоемкость, численность исполнителей и длительность выполнения каждого вида работ представлены в таблице 3.2.1.
Таблица 3.2.1. Этапы реализации проекта.
|
№
|
Этап разработки
|
Исполнитель
|
Трудоемкость, человекодней
|
Количество дней
|
|
1
|
Техническое
задание (ТЗ)
|
Начальник ЦП
|
3
|
4
|
|
|
|
Ст. науч. сотр.
|
4
|
|
|
2
|
Техническое предложение (ТП)
|
Начальник ЦП
|
5
|
6
|
|
|
|
Ст. науч. сотр.
|
3
|
|
|
|
|
Дипломник
|
6
|
|
|
3
|
Сбор и анализ существующей информации
|
Ст. науч. сотр.
|
4
|
8
|
|
|
|
Дипломник
|
13
|
|
|
4
|
Численное моделирование
|
Ст. науч. сотр.
|
8
|
17
|
|
|
|
Дипломник
|
17
|
|
|
5
|
Построение аналитического макета
|
Ст. науч. сотр.
|
10
|
13
|
|
|
|
Дипломник
|
13
|
|
|
6
|
Оптимизация структуры с помощью макетов
|
Ст. науч. сотр.
|
15
|
25
|
|
|
|
Дипломник
|
25
|
|
|
7
|
Численное моделирование после оптимизации
|
Ст. науч. сотр.
|
4
|
11
|
|
|
|
Дипломник
|
11
|
|
|
8
|
Контроль результатов
|
Начальник ЦП
|
6
|
7
|
|
|
|
Дипломник
|
7
|
|
|
9
|
Итоговая презентация результатов
|
Дипломник
|
3
|
3
|
|
10
|
Подготовка документации и сдача темы
|
Начальник ЦП
|
2
|
3
|
|
|
|
Ст. науч. сотр.
|
3
|
|
|
Итого:
|
162
|
97
|

|
Рис.3.1. План график работы по теме проекта.
|
3.3 Бизнес-план
Проектируемый продукт предназначен для применения и использования в приборно-технологическом моделировании при производстве фоточувствительных приборов с зарядовой свзяью с обратной засветкой. При использовании данного метода повышается точность контроля, уменьшается доля бракованной продукции, снижается риск необоснованных регулировок технологического процесса. Конкуренция отсутствует, поскольку продукт является государственным заказом. Цена на изделие будет установлена в зависимости от объема и важности работы.
3.4 Расчет затрат и договорной цены
Стоимость разработки можно определить путем составления сметы затрат, которые в свою очередь, определяются путем расчета затрат по отдельным статьям расходов с их последующим суммированием:
- Материалы, покупные изделия, полуфабрикаты.
- Специальное оборудование.
- Основная заработная плата персонала.
- Дополнительная заработная плата персонала.
- Отчисления в страховые фонды.
- Командировки.
- Контрагентские расходы.
- Накладные расходы.
Затраты по статьям 2, 6 и 7 отсутствуют.
Затраты на материалы, покупные изделия и полуфабрикаты
Данные работы потребовали затрат, связанных с расходами материалов и покупных изделий. Основные материалы и изделия с указанием их цены представлены в таблице 3.4.1.
Таблица 3.4.1. Материалы, покупные изделия, полуфабрикаты.
|
№ п/п
|
Наименование
|
Единица измерения
|
Количество (штук)
|
Цена, рублей
|
Стоимость, рублей
|
|
1
|
2
|
3
|
4
|
5
|
6
|
|
1
|
Бумага
(формат А)
|
Пачка
|
1
|
500
|
500
|
|
2
|
Картридж для принтера
|
Шт.
|
1
|
4000
|
4000
|
|
3
|
Канцтовары
|
-
|
-
|
500
|
500
|
|
4
|
САПР TCAD Synopsys
|
Годовая лицензия
|
1
|
122162
|
122162
|
|
Итого:
|
127162
|
Основная заработная плата персонала
Основная заработная плата вычисляется путем вычисления дневной заработной платы сотрудника и последующего умножения на количество дней, которое сотрудник отработал в проекте.
Основная заработная плата сотрудника вычисляется по формуле:
[З/П] = [Средняя дневная 3/П] [Число дней]
Средняя дневная заработная плата равна окладу сотрудника, поделенному на количество рабочих дней в месяце:
[Средняя дневная 3/П] = [Оклад] / [22 рабочих дня]
Таблица 3.4.2. Основная заработная плата
|
№
|
Этап разработки
|
Исполнитель
|
Трудоемкость, человекодней
|
Оклад, руб
|
Оплата за день, руб
|
Оплата за этап, руб
|
|
1
|
Техническое
задание (ТЗ)
|
Начальник ЦП
|
3
|
30000
|
1363
|
4089
|
|
|
|
Ст. науч. сотр.
|
4
|
20000
|
909
|
3636
|
|
2
|
Техническое предложение (ТП)
|
Начальник ЦП
|
5
|
30000
|
455
|
6815
|
|
|
|
Ст. науч. сотр.
|
3
|
20000
|
909
|
2727
|
|
|
|
Дипломник
|
6
|
10000
|
455
|
2730
|
|
3
|
Сбор и анализ существующей информации
|
Ст. науч. сотр.
|
4
|
20000
|
909
|
3636
|
|
|
|
Дипломник
|
13
|
10000
|
455
|
5915
|
|
4
|
Численное моделирование
|
Ст. науч. сотр.
|
8
|
20000
|
909
|
7272
|
|
|
|
Дипломник
|
17
|
10000
|
455
|
7735
|
|
5
|
Построение аналитического макета
|
Ст. науч. сотр.
|
10
|
20000
|
909
|
9090
|
|
|
|
Дипломник
|
13
|
10000
|
455
|
5915
|
|
6
|
Оптимизация структуры с помощью макетов
|
Ст. науч. сотр.
|
15
|
20000
|
909
|
13635
|
|
|
|
Дипломник
|
25
|
10000
|
455
|
11375
|
|
7
|
Численное моделирование после оптимизации
|
Ст. науч. сотр.
|
4
|
20000
|
909
|
3636
|
|
|
|
Дипломник
|
11
|
10000
|
455
|
5005
|
|
8
|
Контроль результатов
|
Начальник ЦП
|
6
|
30000
|
1363
|
8178
|
|
|
|
Дипломник
|
7
|
10000
|
455
|
3185
|
|
9
|
Итоговая презентация результатов
|
Дипломник
|
3
|
10000
|
455
|
1365
|
|
10
|
Подготовка документации и сдача темы
|
Начальник ЦП
|
2
|
30000
|
1363
|
2726
|
|
|
|
Ст. науч. сотр.
|
3
|
20000
|
909
|
2727
|
|
Итого:
|
|
111392
|
Дополнительная заработная плата
На статью «Дополнительная заработная плата персонала» относят выплаты, предусмотренные КЗОТ РФ за не проработанное по уважительным причинам время: оплата очередных отпусков, времени, связанного с выполнением государственных и общественных обязанностей. Это составляет 30% от суммы основной заработной платы.
[Дополнительная З/П] = [З/П] 30%
[Дополнительная З/П] = 111392 0,3 = 33417 руб.
Суммарные затраты на заработную плату приведены в таблице 3.4.3.
Таблица 3.4.3. Затраты на заработную плату
|
Должность
|
Общая длительность работы, дней
|
Месячный оклад, руб
|
Сумма основной з/п, руб
|
Сумма дополни-тельной з/п, руб
|
Итого расходов на з/п, руб
|
|
Начальник ЦП
|
16
|
30000
|
21808
|
6542
|
28350
|
|
Ст. науч. сотр.
|
51
|
20000
|
46359
|
13907
|
60266
|
|
Дипломник
|
95
|
10000
|
43225
|
12967
|
56192
|
|
Итого:
|
111392
|
33417
|
144809
|
Общая сумма выплат сотрудникам по заработной плате составит 144809 рублей.
Отчисления на страховые взносы
По налоговому кодексу, сумма отчислений на страховые взносы для каждого сотрудника зависит от налогооблагаемой базы. В данном случае эти отчисления составляют 34,2% к сумме основной и дополнительной заработной плате:
[Страховые взносы] = [Итоговая 3/П] 34,2%
144809 0,342 = 49524 рублей
Накладные расходы
К статье «Накладные расходы» относятся транспортные расходы, а также расходы по содержанию и ремонту зданий, оборудования, инвентаря и другие расходы (200% от суммы основной заработной платы).
[Накладные расходы] = [Основная З/П] 200%
[Накладные расходы] = 111392 2 = 222784 рубля
Таблица 3.4.4. Итоговая таблица по смете затрат
|
№
|
Наименование статей затрат
|
Сумма, руб
|
|
1
|
Материалы, покупные изделия, полуфабрикаты.
|
127162
|
|
2
|
Специальное оборудование.
|
-
|
|
3
|
Основная заработная плата персонала.
|
111392
|
|
4
|
Дополнительная заработная плата персонала.
|
33417
|
|
5
|
Отчисления на страховые взносы.
|
49524
|
|
6
|
Командировки.
|
-
|
|
7
|
Контрагентские расходы.
|
-
|
|
8
|
Накладные расходы.
|
222784
|
|
Итого:
|
544279
|
Договорная цена состоит из общих затрат, прибыли и НДС. Поскольку разработка не тиражируется, то НДС в цену не входит. Норматив прибыли берем в размере 30% от стоимости разработки:
544279 0,3 =163283 руб.
Договорная цена:
544279 + 163283 = 707562 руб.
3.5. Обоснование целесообразности разработки
Разработка методики моделирования ФПЗС необходима для нахождения оптимальных конструктивно-технологических параметров подложки ФПЗС и величин управляющих воздействий на основе результатов моделирования величины модуляции сигнала фотоприемной ПЗС-ячейки.
Методики практического моделирования технологического процесса ФПЗС с обратной засветкой на базе коммерческого пакета приборно-технологического моделирования Sentaurus TCAD (Synopsys) необходимы для разработки продукции ОАО “НПП “Пульсар”. В результате сокращается время разработки продукции и увеличивается экономическая эффективность работы.
Выводы
В организационно-экономической части дипломной работы раскрывается краткое содержание основных разделов бизнес-плана проекта, проводится анализ требуемых затрат времени и денежных средств для его реализации.
Организационная схема проекта, приведенная в этом разделе показывает, что для его выполнения необходима группа экспертов из трех человек, которые должны реализовать проект за 97 рабочих дней.
Стоимость реализации проекта составит 707562 рубль.
Экономическая целесообразность реализации данного проекта доказана, так как разработка необходима при проектировании фоточувствительных приборов с зарядовой связью с обратной засветкой в ОАО “НПП “Пульсар”.
Использованная литература
1. Пресс Ф.П. Фоточувствительные приборы с зарядовой связью. М.: Радио и связь, 1991. 264 с.
2. Е. В. Костюков, А. М. Маклаков, А. С. Скрылёв, В. В. Чернокожий. Состояние и уровень развития фоточувствительных приборов с зарядовой связью. Электронная техника. Серия 2. Полупроводниковые приборы, 2007, вып. 2(219), с. 3-20.
3. Jan T. Bosiers, Inge M. Peters, Cees Draijer, Albert Theuwissen, “Technical Challenges and Recent Progress in CCD Imagers”, Nuclear Inst. And Methods in Physics Research A, Sept. 2006, pp. 148-156.
4. Stephen E. Holland, William F. Kolbe, and Christopher J. Bebek, "Device design for a 12.3 Mpixel, Fully Depleted, Back-Illuminated, High-Voltage Compatible Charge-Coupled Device," IEEE Trans. Elec. Dev. 56, 2612-2622 (2009)
5. Janesik J. R. Sientific charge-coupled devices. SPIE press. Bellingham, WA, 2001. 908 p.
6. T. M. V. Bootsma ; Henry J. M. Aarts ; Marcel L. van den Berg ; A. C. Brinkman ; Antonius J. F. den Boggende, et al. "Back-illuminated CCDs developed for the reflection grating spectrometer on board XMM", Proc. SPIE 2808, EUV, X-Ray, and Gamma-Ray Instrumentation for Astronomy VII, 481 (October 31, 1996);
7. Hubble space telescope: Wide field-planetary camera instrument handb.: Version 3.0
Space telescope science inst;J.W.MacKenty, R.E.Griffiths, W.B.Sparks et al. - Baltimore (MD). - 1992. - 109 с
8. Paul Vu, Xinqiao (Chaio) Liu, and Dan Laxson. Large area detectors and new sensor technologies at Fairchild Imaging. Proc. SPIE Vol. 6276, 627605 (Jun. 15, 2006)
9. S. E. Holland, D. E. Groom, N. P. Palaio, R. J. Stover, and M. Wei. Fully depleted, back-illuminated charge-coupled devices fabricated on high-resistivity silicon - IEEE. Trans. Elec. Dev., : 50 (2003) 225.
10.S. E. Holland, K. Dawson, N. P. Palaio, J. Saha, N. A. Roe, G. Wang, "Fabrication of back-illuminated, fully depleted charge-coupled devices," Nucl. Instrum. Methods A 579,, 653-657 (2007)
11. Westhoff, R. C. et al. “Low dark current, back-illuminated charge coupled devices.” Sensors, Cameras, and Systems for Industrial/Scientific Applications X. Ed. Erik Bodegom & Valerie Nguyen. San Jose, CA, USA: SPIE, 2009. 72490J-11. © 2009 SPIE
12. Stephen E. Holland, William F. Kolbe, and Christopher J. Bebek, "Device design for a 12.3 Mpixel, Fully Depleted, Back-Illuminated, High-Voltage Compatible Charge-Coupled Device," IEEE Trans. Elec. Dev. 56, 2612-2622 (2009)
6. A. Karcher, C.J. Bebek, W. F. Kolbe, D. Maurath, V. Prasad, M. Uslenghi, M. Wagner, "Measurement of Lateral Charge Diffusion in Thick, Fully Depleted, Back-illuminated CCDs," IEEE Trans. Nucl. Sci. 51 (5), (18 pages) (2004)
7. Бокшанский В.Б., Карасик В.Е. Расчет характеристик фоточувствительных приборов с зарядовой связью. М.; МГТУ им. Н.Э.Баумана, 2002. - 52с.
9. http://www.roperscientific.de/
13. А. Гонта. ФУНКЦИЯ ПЕРЕДАЧИ МОДУЛЯЦИИ И ТЕЛЕВИЗИОННЫЕ ИСПЫТАТЕЛЬНЫЕ ТАБЛИЦЫ ИЗМЕРЕНИЕ ПАРАМЕТРОВ ВИДЕОКАМЕР НА ЛЮБОЙ ВКУС. АЛГОРИТМ БЕЗОПАСНОСТИ № 3, 2013
14. Perry, B. Algorithm for MTF estimation by histogram modeling of an edge. New York: Center for Imaging Science Rochester Institute of Technology Rochester, 2001.
15. Xujie Zhang ; Tamar Kashti ; Dror Kella ; Tal Frank ; Doron Shaked, et al.
"Measuring the modulation transfer function of image capture devices: what do the numbers really mean?", Proc. SPIE 8293, Image Quality and System Performance IX, 829307 (January 24, 2012);
16. С.А. Родионов Основы оптики// Конспект лекций. СПб. СПб ГИТМО (ТУ) – 2000
17. Гершанов В.Ю. Методы и алгоритмы структурно-физического моделирования элементов интегральных схем в диффузионно-дрейфовом приближении / В.Ю. Гершанов, С.И. Гармашов Ростов-на-Дону: изд. РГУ, 2000. - 18 с.
18. Synopsys. (2008). Sentaurus Device User Guide. Synopsys Inc.
19Emi Miyata et al. Direct X-Ray Imaging of µm Precision Using Back-Illuminated Charge-Coupled Device .2002 Jpn. J. Appl. Phys. 41 L500
20 Ландсберг Г.С. Оптика, 6-е издание, Физматлит 2004
21
Приложение А
line x location=0.0 spacing= 0.01 tag=SiTop
line x location=50.0 spacing = 0.01 tag=SiBottom
region silicon xlo=SiTop xhi=SiBottom
init concentration=1.2e14 field=Boron wafer.orient=100
mgoals min.normal.size=0.01 max.lateral.size=0.05 normal.growth.ratio=1.4
# ( No4 Oxidation 0,0425 mkm )
gas_flow name=O2_H2 flowO2=0.7 flowH2=0.3
temp_ramp name=n4 temperature=850<C> time=40<min> N2
temp_ramp name=n4 temperature=850<C> time=25<min> N2 trate=4<C/min>
temp_ramp name=n4 temperature=950<C> time=16<min> N2
temp_ramp name=n4 temperature=950<C> time=10<min> O2
temp_ramp name=n4 temperature=950<C> time=10<min> gas.flow=O2_H2
temp_ramp name=n4 temperature=950<C> time=15<min> N2
temp_ramp name=n4 temperature=950<C> time=35<min> N2 trate=-4.286<C/min>
temp_ramp name=n4 temperature=800<C> time=25<min> N2 last
diffuse temp.ramp=n4
# ( No 5 DEPOSIT NITRIDE 110 nm )
deposit nitride thickness=0.11 type=isotropic
# ( No10 OXIDATION 250 nm )
temp_ramp name=n10 temperature=850<C> time=40<min> N2
temp_ramp name=n10 temperature=850<C> time=35<min> N2 trate=4.286<C/min>
temp_ramp name=n10 temperature=1000<C> time=70<min> N2
temp_ramp name=n10 temperature=1000<C> time=50<min> N2 trate=-4<C/min>
temp_ramp name=n10 temperature=800<C> time=25<min> N2 last
diffuse temp.ramp=n10
# ( No11+12 NITRIDE AND OXIDE REMOVE )
etch nitride thickness=0.11 rate= {1} etchstop.overetch=0.01
etch oxide thickness=0.0425 rate= {1} etchstop.overetch=0.01
# ( No13 OXIDATION 42.5 nm )
diffuse temp.ramp=n4
# ( No14 DEPOSIT NITRIDE 110 nm )
deposit nitride thickness=0.11 type=isotropic
# ( No 21 LOCAL OXIDATION )
temp_ramp name=n21 temperature=850<C> time=40<min> N2
temp_ramp name=n21 temperature=850<C> time=50<min> N2 trate=2<C/min>
temp_ramp name=n21 temperature=950<C> time=16<min> N2
temp_ramp name=n21 temperature=950<C> time=10<min> N2
temp_ramp name=n21 temperature=950<C> time=400<min> N2
temp_ramp name=n21 temperature=950<C> time=15<min> N2
temp_ramp name=n21 temperature=950<C> time=50<min> N2 trate=-2<C/min>
temp_ramp name=n21 temperature=850<C> time=25<min> N2 last
diffuse temp.ramp=n21
# ( No22 MASK for STOP KANAL )
# Etch(material=Nitride, remove=115nm, rate(a1=1000), over=1)
# ( No 27 OXIDE REMOVING ALL - 250 nm )
etch oxide thickness=0.255 rate= {1} etchstop.overetch=0.01
# ( No 28 LOCAL OXIDATION )
temp_ramp name=n28 temperature=850<C> time=40<min> N2
temp_ramp name=n28 temperature=850<C> time=35<min> N2 trate=4.286<C/min>
temp_ramp name=n28 temperature=1000<C> time=16<min> N2
temp_ramp name=n28 temperature=1000<C> time=10<min> O2
temp_ramp name=n28 temperature=1000<C> time=55<min> H2O
temp_ramp name=n28 temperature=1000<C> time=15<min> N2
temp_ramp name=n28 temperature=1000<C> time=50<min> N2 trate=-3<C/min>
temp_ramp name=n28 temperature=850<C> time=25<min> N2 last
diffuse temp.ramp=n28
# ( 'No 30 OXIDE REMOVING IN LOCOS' )
etch oxide thickness=0.04 rate= {1} etchstop.overetch=0.01
# ( No 30 NITRIDE REMOVING ALL - 110 nm )
etch nitride thickness=0.115 rate= {1} etchstop.overetch=0.01
# ( No 30 OXIDE REMOVING DO DOROZKI SKRAIBIROVANIA )
etch oxide thickness=0.0425 rate= {1} etchstop.overetch=0.01
# ( No 32 oxidation 35 nm )
temp_ramp name=n32 temperature=850<C> time=40<min> N2
temp_ramp name=n32 temperature=850<C> time=25<min> N2 trate=4<C/min>
temp_ramp name=n32 temperature=950<C> time=16<min> N2
temp_ramp name=n32 temperature=950<C> time=10<min> O2
temp_ramp name=n32 temperature=950<C> time=8<min> gas.flow=O2_H2
temp_ramp name=n32 temperature=950<C> time=15<min> N2
temp_ramp name=n32 temperature=950<C> time=35<min> N2 trate=-4.286<C/min>
temp_ramp name=n32 temperature=800<C> time=25<min> N2 last
diffuse temp.ramp=n32
# ( No 33 TRAVLENIE 35 nm )
etch oxide thickness=0.035 rate= {1} etchstop.overetch=0.02
# ( No 34 Oxidation 50 nm UNDER GATE )
gas_flow name=O2_0.1_N2_0.9 flowO2=0.1 flowN2=0.9
gas_flow name=O2_0.5_H2_0.4 flowO2=0.5 flowH2=0.4
temp_ramp name=n34 temperature=800<C> time=30<min> N2
temp_ramp name=n34 temperature=800<C> time=14<min> trate=7.143<C/min> gas_flow=O2_0.1_N2_0.9
temp_ramp name=n34 temperature=900<C> time=6<min> gas_flow=O2_0.1_N2_0.9
temp_ramp name=n34 temperature=900<C> time=5<min> O2
temp_ramp name=n34 temperature=900<C> time=22<min> gas_flow=O2_0.5_H2_0.4
temp_ramp name=n34 temperature=900<C> time=10<min> N2
temp_ramp name=n34 temperature=900<C> time=67<min> N2 trate=-1.493<C/min>
temp_ramp name=n34 temperature=800<C> time=25<min> N2 last
diffuse temp.ramp=n34
# ( No 35 DEPOSIT NITRIDE 65 nm )
deposit nitride thickness=0.065 type=isotropic
# ( No 36 SI3N4 OXIDATION )
temp_ramp name=n36 temperature=850<C> time=40<min> N2
temp_ramp name=n36 temperature=850<C> time=35<min> N2 trate=4.286<C/min>
temp_ramp name=n36 temperature=1000<C> time=16<min> N2
temp_ramp name=n36 temperature=1000<C> time=10<min> N2
temp_ramp name=n36 temperature=1000<C> time=50<min> N2
temp_ramp name=n36 temperature=1000<C> time=15<min> N2
temp_ramp name=n36 temperature=1000<C> time=50<min> N2 trate=-4<C/min>
temp_ramp name=n36 temperature=800<C> time=25<min> N2 last
diffuse temp.ramp=n36
# ( Arsenicum IMPLANT )
implant Arsenic energy=380 dose=1.25e12
# ( diffusion 7)
temp_ramp name=n_impl temperature=850<C> time=25<min> N2
temp_ramp name=n_impl temperature=850<C> time=15<min> N2
temp_ramp name=n_impl temperature=850<C> time=35<min> N2 trate=4.286<C/min>
temp_ramp name=n_impl temperature=1000<C> time=420<min> N2
temp_ramp name=n_impl temperature=1000<C> time=50<min> N2 trate=-4<C/min>
temp_ramp name=n_impl temperature=800<C> time=25<min> N2 last
diffuse temp.ramp=n_impl
# ( No 40 SI3N4 OXIDATION )
diffuse temp.ramp=n36
# ( No 41 1-nd POLYSILICON DEPOSITION (0.5-0.6 mkm )
deposit poly thickness=0.55
#element=P concentration=1e20
# ( No 43 DIFFUSIA FOSFORA - TEMPERATURES )
temp_ramp name=n_41 temperature=900<C> time=90<min> N2
diffuse temp.ramp=n_41
temp_ramp name=n_43 temperature=850<C> time=101<min> N2
temp_ramp name=n_43 temperature=850<C> time=15<min> N2 trate=-3.333<C/min>
temp_ramp name=n_43 temperature=800<C> time=25<min> N2 last
diffuse temp.ramp=n_43
# ( No 49 1-GO POLY-Si OXIDATION )
temp_ramp name=n49 temperature=850<C> time=40<min> N2
temp_ramp name=n49 temperature=850<C> time=35<min> N2 trate=4.286<C/min>
temp_ramp name=n49 temperature=1000<C> time=16<min> N2
temp_ramp name=n49 temperature=1000<C> time=10<min> N2
temp_ramp name=n49 temperature=1000<C> time=16<min> N2
temp_ramp name=n49 temperature=1000<C> time=15<min> N2
temp_ramp name=n49 temperature=1000<C> time=50<min> N2 trate=-4<C/min>
temp_ramp name=n49 temperature=800<C> time=25<min> N2 last
diffuse temp.ramp=n49
# ( No 53 OTZIG 900gr - 10min )
temp_ramp name=n_53 temperature=900<C> time=10<min> N2 last
diffuse temp.ramp=n_53
# ( No 59 DIFFUSIA FOSFORA - TEMPERATURES )
diffuse temp.ramp=n_43
# ( No 66 oxidation 25 nm )
temp_ramp name=n66 temperature=850<C> time=40<min> N2
temp_ramp name=n66 temperature=850<C> time=10<min> N2
temp_ramp name=n66 temperature=850<C> time=30<min> N2
temp_ramp name=n66 temperature=850<C> time=65<min> N2
temp_ramp name=n66 temperature=850<C> time=35<min> N2 trate=-1.428<C/min>
temp_ramp name=n66 temperature=800<C> time=25<min> N2 last
diffuse temp.ramp=n66
# ( 26.036 IMPLANTATION STOK )
implant Arsenic energy=100 dose=1.25e15 tilt=7 rotation=0
implant Arsenic energy=100 dose=1.25e15 tilt=7 rotation=90
implant Arsenic energy=100 dose=1.25e15 tilt=7 rotation=180
implant Arsenic energy=100 dose=1.25e15 tilt=7 rotation=270
temp_ramp name=n_26.036 temperature=900<C> time=30<min> N2 last
diffuse temp.ramp=n_26.036
#etch resist
deposit oxide thickness=0.5 type=isotropic
# ( 32.140 OXIDATION 250 A - TEMPERATURES ONLY!!! )
temp_ramp name=n32.140 temperature=850<C> time=20<min> N2
temp_ramp name=n32.140 temperature=850<C> time=18<min> N2
temp_ramp name=n32.140 temperature=850<C> time=40<min> N2 last
diffuse temp.ramp=n32.140
# ( 32.121 SiO2 FIRM )
temp_ramp name=n32.121 temperature=850<C> time=20<min> N2
temp_ramp name=n32.121 temperature=850<C> time=10<min> N2 trate=7<C/min>
temp_ramp name=n32.121 temperature=920<C> time=90<min> N2
temp_ramp name=n32.121 temperature=920<C> time=20<min> N2 trate=-3.5<C/min>
temp_ramp name=n32.121 temperature=850<C> time=10<min> N2 last
diffuse temp.ramp=n32.121
# ( 32.125 HETTER ONLY TEMPERATURE )
temp_ramp name=n32.125 temperature=1040<C> time=5<min> trate=6<C/min>
temp_ramp name=n32.125 temperature=1070<C> time=13<min>
temp_ramp name=n32.125 temperature=1070<C> time=80<min> trate=-3.625<C/min>
temp_ramp name=n32.125 temperature=780<C> time=5<min> last
diffuse temp.ramp=n32.125
# ( No 78 OTZIG 850gr - 30min )
temp_ramp name=n78 temperature=850<C> time=70<min> N2
temp_ramp name=n78 temperature=850<C> time=15<min> N2 trate=-3.333<C/min>
temp_ramp name=n78 temperature=800<C> time=25<min> N2 last
diffuse temp.ramp=n78
# ( No 80 OPLAVLENIE BFSS - 850gr - 30min )
diffuse temp.ramp=n78
# ( No 81 OTZIG 550gr - 20min )
temp_ramp name=n81 temperature=850<C> time=70<min> N2
diffuse temp.ramp=n81
struct tdr=1_new_ccd1d_14.04.14
44
44
PAGE \* MERGEFORMAT 1
Проектирование фоточувствительных приборов с зарядовой связью с обратной засветкой в ОАО “НПП “Пульсар”