КЛАССИФИКАЦИЯ ИМС
PAGE 1
Лекция - 7
КЛАССИФИКАЦИЯ ИМС
Интегральные микросхемы представляют собой наиболее распространенные изделия микроэлектроники, методы изготовления которых основаны на обобщении как ранее используемых в полупроводниковом производстве и при получении пленочных покрытий групповых технологических приемов, так и новых технологических процессов. Этим определяются два главных направления в создании ИМС: полупроводниковое и пленочное. Интегральные микросхемы обычно классифицируют по конструктивно-технологическим признакам, степени интеграции, функциональному назначению, быстродействию, потребляемой мощности, применяемости в аппаратуре, а также прин ципу действия активных элементов. Наиболее распространена классификация по конструктивно-технологическим признакам, поскольку при этом в обозначении ИМС содержится информация о ее конструкции и технологии изготовления.
Одним из основных критериев оценки технологического уровня производства и отработанности конструкции ИМС является степень интеграции.
Важным конструктивным признаком, по которому можно все ИМС подразделить на два класса, является тип подложки (с активной или пассивной). К первому классу относятся ИМС, элементы которых выполнены внутри подложки, представляющей собой пластину из полупроводникового материала, а ко второму — ИМС, элементы которых размещены на поверхности подложки, выполненной из диэлектрического материала. Тип подложки зависит от технологии изготовления ИМС. Полупроводниковые ИМС выполняют на активных и пассивных подложках, пленочные и гибридные - на пассивных, а СВЧ и пьезокерамические- также на пассивных..
Классификация ИМС по конструктивно-технологическим признакам показана на рис. 49.
Основными и наиболее сложными элементами ИМС любого типа являются биполярные и униполярные транзисторы. В гибридных ИМС используют бескорпусные дискретные биполярные и униполярные (чаще всего на МОП-структурах) транзисторы, изготовляемые по планарно-эпитаксиальной технологии. Кроме того, в гибридных ИМС используют диоды и
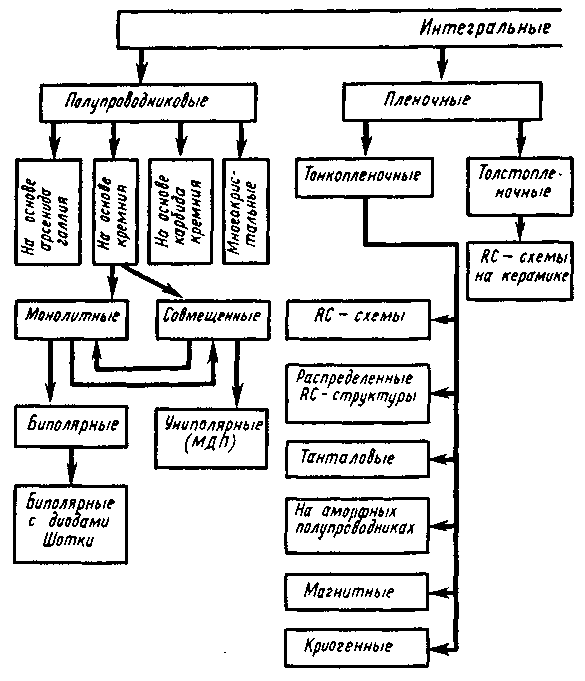
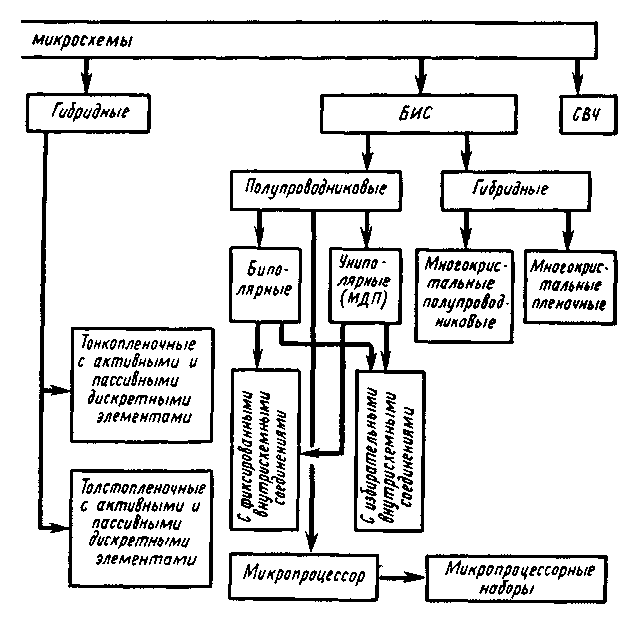
Рис.1. Классификация интегральных микросхем
по конструктивно-технологическим признакам
бескорпусные полупроводниковые ИМС. В полупроводниковых ИМС применяют биполярные и МОП-транзисторы,в основном изготовляемые по планарной технологии.
Для защиты ИМС от внешних воздействий их герметизируют, заключая в специальных корпусах или спрессовывая в пластмассу (корпусные ИМС), либо покрывают эпоксидным или другими лаками (бескорпусные).
По функциональному назначению различают цифровые, аналоговые (линейные), аналого-цифровые и цифроаналоговые ИМС, а по применяемости в аппаратуре - широкого применения и специальные.
В настоящее время ИМС являются основой элементной базы практически всех видов радиоэлектронной аппаратуры. Для построения радиоэлектронной аппаратуры различного назначения необходимы не отдельные ИМС, а функционально полные их серии, т. е. совокупность ИМС, выполняющих различные функции, имеющих единую конструктивно-технологическую основу и предназначенных для совместного применения.
Состав серии в основном определяется функциональной полнотой отдельных ИМС, удобством построения из них сложных устройств, а также типом стандартного корпуса. В зависимости от функционального назначения и областей применения серии могут содержать от трех-четырех до нескольких десят-иов ИМС различных типов. По мере развития схемотехники и тенологии изготовления ИМС состав перспективных серий может изменяться и расширяться.
В соответствии с принятой ГОСТ 18682-73 системой условных обозначений все выпускаемые ИМС по конструктивно-технологическому исполнению подразделяются на три группы: полупроводниковые, гибридные и прочие. К прочим относят пленочные ИМС, которые в настоящее время выпускаются в ограниченном количестве, а также вакуумные, керамические и др. Цифрами 1, 5 и 7 обозначают полупроводниковые ИМС (7 — бескорпусные) ; 2, 4, 6,8 — гибридные, а 3 — прочие.
В зависимости от характера выполняемых в радиоэлектронной аппаратуре функций ИМС подразделяются на подгруппы (например, генераторы, усилители, триггеры) и виды (например, преобразователи частоты, фазы, напряжения).
Условные обозначения ИМС состоят из четырех элементов (причем первые два элемента - три-четыре цифры - характеризуют полный номер серии):
первый элемент - цифра, указывающая конструктивно-технологическую группу;
второй элемент — две-три цифры, указывающие порядковый номер разработки данной серии ИМС;
третий элемент — две буквы, указывающие подгруппу и вид ИМС;
четвертый элемент - одна или несколько цифр, указывающие порядковый номер разработки ИМС в данной серии, которая может содержать несколько одинаковых по функциональному признаку ИМС.
Пример расшифровки обозначения микросхемы интегрального полупроводникового операционного усилителя приведен на рис. 50. В некоторых случаях в конце условного обозначения дополнительно имеется буква, указывающая технологический разброс электрических параметров данного типономинала.
Под типономиналом ИМС понимают микросхему, имеющую конкретное функциональное назначение и условное обозначение, а под типом ИМС — совокупность типономиналов микросхем, также имеющих конкретное функциональное назначение и условное обозначение. Конкретные значения электрических параметров и отличия типономиналов ИМС приводятся в технической документации.
В некоторых сериях буква в конце условного обозначения ИМС указывает тип корпуса, в котором выпускается ИМС данного типономинала (П — пластмассовый, М — керамический) . В начале условного обозначения микросхем широкого применения стоит буква К (например, К140УД11).

Рис. 2. Пример расшифровки условного обозначения полупроводниковой
интегральной микросхемы

Рис. 3. Пример расшифровки обозначения логического элемента
И-НЕ/ИЛИ-НЕ до введения ГОСТ 18682-73
Если после буквы К перед номером серии имеется также буква М, это означает, что вся данная серия выпускается в керамическом корпусе (например, КМ155ЛА1).
Перед обозначением серии бескорпусных ИМС без присоединения выводов к кристаллу имеется буква Б (например, КБ524РП1А4).
Цифра, стоящая после дефиса в обозначении бескорпусных ИМС (например, 703ЛБ1-2), означает возможные варианты их конструктивных исполнений: 1-с гибкими выводами; 2-с ленточными (паучковыми), в том числе на полиимидной пленке; 3-с жесткими; 4 — на общей пластине (неразделенные) ; 5 — разделенные без потери ориентации (например, наклеенные на пленку); 6 — с контактными площадками без выводов (кристалл).
Следует отметить, что до введения ГОСТ 18682 - 73 условные обозначения присваивались в соответствии с нормативно-технической документацией, действовавшей в то время. После 1973 г. большинство ИМС получили новые условные обозначения. Однако ИМС, на которые не была выпущена новая техническая документация, сохранили старые условные обозначения. Пример такого обозначения приведен на рис. 51.
СПОСОБЫ ИЗОЛЯЦИИ ЭЛЕМЕНТОВ ПОЛУПРОВОДНИКОВЫХ ИМС
Как пассивные, так и активные элементы полупроводниковых ИМС имеют электрическую связь с общей полупроводниковой пластиной, а также друг с другом, поэтому их необходимо изолировать. Электрическую изоляцию элементов выполняют следующими способами:
обратно включенным р-п-переходом;
диэлектрической пленкой;
формированием островковых структур.
Изоляция элементов ИМС обратно включенным
р-п-п ереходом – наиболее распространенный способ, сущность которого состоит в формировании в исходной пластине дополнительных р-л-переходов, окружающих каждый элемент или группу элементов ИМС. Такие дополнительные р-п-переходы,, называемые изолирующими, получают либо диффузией, либо эпитаксией и последующей диффузией.

Рис. 4. Изолированные области Рис. 58. Изолированные области (п-типа), создаваемые диффузи- п-типа, создаваемые в эпитакси
ей примесных атомов в пластине альном слое диффузией акцеп-
р-типа торной примеси
При диффузионном методе получения изолирующих р-л-переходов на первой операции диффузии в подложке р-типа (рис. 57) формируют области л-типа электропроводности, имеющие заданную конфигурацию, а на последующих стадиях технологического процесса в этих областях создают необходимые элементы ИМС. Так как при таком способе изоляции между элементами ИМС действуют два встречно включенных р-л-перехода, при любых электрических потенциалах, приложенных к каждой изолированной л-области, один из р-п-переходов будет включен в обратном направлении. Поскольку область объемного заряда обратно включенного р-п-перехода лишена подвижных носителей, ее удельное сопротивление близко к удельному сопротивлению диэлектрика. Взаимно изолированные области пластины (в данном случае области п-типа) называюу карманами. При способе изоляции р-п-переходом напряжение пробоя между двумя соседними карманами достигает 50 - 80 В, а токи утечки через обратно включенные р-п-переходы не превышают нескольких наноампер. В результате обеспечивается достаточно надежная изоляция элементов, создаваемых внутри карманов. Барьерные емкости обратно включенных р-п-переходов вызывают паразитные взаимодействия, что существенно ограничивает частотный диапазон ИМС.
В современных типах ИМС наиболее часто используют эпитаксиальный способ изоляции элементов ИМС, при котором на кремниевой пластине электропроводности р-типа, например (рис. 58), выращивают монокристаллический слой п-типа электропроводности, имеющий толщину 5 — 10 мкм. Затем через этот слой проводят диффузию, получая области р -типа, которые частично перекрывают исходную пластину р-типа электропроводности. Так создают области п-типа (карманы), изолированные друг от друга р-п-переходами.
Изоляция элементов ИМС диэлектрической пленкой диоксида или нитрида кремния также довольно распространенный способ, называемый эпик-процессом. Сущность его состоит в следующем. В исходной пластине монокристаллического кремния вытравливают канавки глубиной 10 - 15 мкм, окисляют поверхность и выращивают толстый слой поликристаллического кремния, который заполняет рельеф. Затем с нижней стороны поверхность исходной пластины сошлифовывают вплоть до дна вытравленных канавок, получая таким образом монокристаллические области, окруженные поликристаллическим кремнием и изолированные диэлектриком (рис. 59).

Рис. 5. Создание монокристаллических Рис. 60. Создание островковой
областей кремния, изолированных изоляции по технологии
диэлектриком в пластине поликрис- кремний на сапфире:
талического кремния: 1,2 – моно- и 1 – кремний, 2 – сапфир
поликристаллический кремний,
3 – диэлектрик
Этот способ обеспечивает надежную изоляцию элементов (пробивные напряжения между соседними областями более 1 кВ), позволяет существенно снизить паразитные емкостные взаимодействия и во много раз - токи утечки. Однако технология получения диэлектрически изолированных областей достаточно сложна и дорогостояща, поэтому такой способ изоляции используют при изготовлении прецизионных аналоговых ИМС.
Островковую изоляцию (рис. 60), выполняемую по КНС-технологии (кремний на сапфире), начали применять недавно. При этом на сапфировой подложке выращивают монокристаллическую пленку кремния толщиной несколько микрометров. Затем химическим травлением удаляют кремний в некоторых локальных областях. В результате на сапфировой подложке образуются взаимно изолированные кремниевые островки. Хорошая изоляция островков и малые паразитные емкости позволяют существенно повысить плотность упаковки элементов и повысить быстродействие ИМС на сапфировых пластинах. Основной недостаток островковой изоляции обусловлен сложным рельефом поверхности, затрудняющим получение надежной металлической разводки.
РЕЗИСТОРЫ ИМС
Резисторы ИМС можно подразделить на диффузионные, пинч-резисторы, ионно-легированные и пленочные.
Исходными данными для определения геометрических размеров резисторов являются их номинальное сопротивление, а также допуск на него, поверхностное сопротивление материала, температурный коэффициент сопротивления, средняя рассеиваемая мощность и точность выполнения технологических операций.
Номинальное сопротивление резисторов определяют по формуле
R = l / (bd),
где - удельное объемное сопротивление материала; l, b и d - длина, ширина и толщина резистивного элемента.
Сопротивление R резистора пропорционально удельному объемному сопротивлению полупроводникового материала, которое зависит от уровня его легирования и температуры. Более высокому уровню легирования соответствует меньшее значение , а следовательно, более низкое сопротивление R, отнесенное к единице длины l при одинаковых значениях ширины и толщины. Следовательно, можно было бы сделать вывод, что при заданной геометрической конфигурации резистивный элемент наиболее целесообразно формировать на беспримесном или слаболегированном полупроводнике. Однако удельное сопротивление такого полупроводника значительно зависит от температуры, что полностью исключает возможность его использования. Поэтому для уменьшения температурной зависимости сопротивления резистора необходим высоколегированный полупроводниковый материал. Увеличение концентрации подвижных носителей зарядов в таком материале вследствие проявления собственной электропроводности будет незначительным по сравнению с концентрацией основных носителей в широком диапазоне температур. Таким образом, номинальное сопротивление резистора в основном зависит от материала с заданным удельным объемным сопротивлением и от его геометрических размеров. Как видно из приведенной выше формулы, сопротивление резистора можно повысить, увеличив его длину или уменьшив площадь поперечного сечения.
Диффузионные резисторы полупроводниковых ИМС наиболее часто формируют на базовых слоях биполярных транзисторов. Выбор этого слоя представляет собой компромиссное решение между большими геометрическими размерами, которые были бы необходимы при использовании эмит-терного слоя, и высоким температурным коэффициентом сопротивления резистора, который соответствовал бы использованию слаболегированного слоя полупроводника (например, коллектора). Однако следует отметить, что на эмиттерном слое можно формировать низкоомные термостабильные резисторы. Структура и конфигурации диффузионных резисторов показаны на рис. 61.
Пинч-резисторы (рис. 62) представляют собой диффузионные резисторы, формируемые на базовых слоях и изолированные двумя параллельно расположенными обратно включенными эмиттерным и коллекторным р-п-переходами. По сравнению с обычными диффузионными резисторами, формируемыми на базовых слоях, пинч-резисторы имеют меньшую площадь поперечного сечения и более высокое удельное сопротивление, так как для их реализации используют слаболегированную часть базы. Поэтому максимальное сопротивление пинч-резис-торов может достигать 300 кОм. Недостатками пинч-резисто-ров являются относительно большой разброс параметров, нелинейность вольт-амперных характеристик и рабочие напряжения, обычно не превышающие 7 — 10 В, так как они определяются напряжением пробоя перехода эмиттер—база.
Ионно-легированные резисторы по структуре не отличаются от обычных диффузионных, однако глубина залегания изолирующего их р-л-перехода значительно меньше и, как правило, не превышает 0,2 — 0,3 мм. Кроме того, ионное легирование обеспечивает получение очень малых концентраций атомов легирующих примесей, что позволяет создавать резисторы, номинальное сопротивление которых достигает сотен килоом.
Пленочные резисторы, получаемые нанесением резисгивного вещества на изолирующую пластину, имеют такую же структуру и конфигурацию, как и диффузионные. Сопротивление пленочных резисторов зависит от материала и толщины пленки и может достигать 1 МОм. После нанесения пленки резисторы обычно подгоняют под заданный номинал различными способами: механическим снятием части резистивного слоя, травлением, низкотемпературным окислением, лазерной обработкой и др.
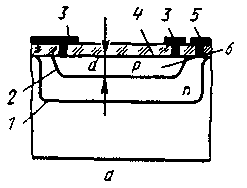
Рис. 6. Структура (а) и конфигурации (б, в, г) диффузионных резисторов: 1,2-р-п-переходы, 3 - омические контакты к резистору, 4 — защитное покрытие (диоксид кремния), 5 - омический контакт к п-области, 6 — проводящий слой

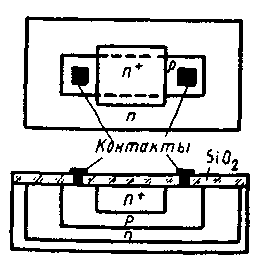
Рис. 7. Пинч-структура диффузионного резистора
Следует отметить, что при построении сложной аппаратуры малых габаритов стремятся использовать ИМС с минимальным количеством резисторов возможно меньших номиналов.
КОНДЕНСАТОРЫ ИМС
Конденсаторы полупроводниковых ИМС обычно выполняют на основе структур обратно включенных р-п-переходов биполярных транзисторов (диффузионные конденсаторы) и структур металл - окисел - полупроводник МОП-транзисторов (МОП-конденсаторы).
Независимо от способа получения конденсаторы характеризуются следующими параметрами:
номинальной емкостью С;
удельной емкостью С0, т. е. емкостью, отнесенной к единице площади;
технологическим разбросом номинальной емкости ± С;
рабочим напряжением Uраб;
температурным коэффициентом емкости ТКС;
добротностью Q.
Диффузионные конденсаторы основаны на использовании барьерной емкости обратно включенных p-n-переходов (рис. 63, а, б). Аналогом диэлектрика в таких конденсаторах является область объемного заряда обратно включенного р-п-перехода, ширина которой зависит от распределения концентраций примесных атомов вблизи его границы и обратного напряжения. Следовательно, барьерная емкость р-п-перехода определяется не только его площадью, но и условиями формирования и обратным напряжением. При использовании диффузионных конденсаторов необходимо соблюдать полярность обратного напряжения, т. е. потенциал п-области всегда должен быть выше потенциала р-области.
Поскольку емкость диффузионных конденсаторов зависит от приложенного напряжения, они могут выполнять роль как постоянных, так и переменных. В качестве постоянных диффузионные конденсаторы работают достаточно хорошо только при обратном напряжении, намного превышающем по абсолютному значению рабочее напряжение.
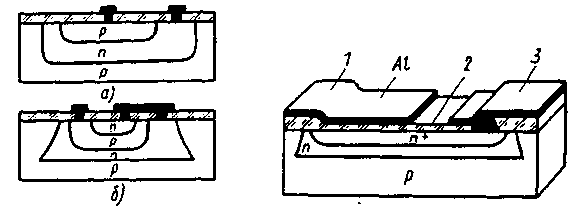
Рис. 63. Структуры диффузной- Рис. 64. Структура МДП-конденсатора:
ных конденсаторов, выполненных 1,3- верхний и нижний электроды,
на основе одного (а) и двух 2 — диэлектрик
параллельно включенных (б)
р-п-переходов
МОП - к онденсаторы (рис. 64), формируемые на основе слоя диоксида кремния или какого-либо другого диэлектрика, отличаются гораздо лучшими электрическими характеристиками, чем диффузионные, и находят широкое применение в различных перспективных полупроводниковых и гибридных ИМС, используемых, в частности, для создания аналоговых устройств. Процесс изготовления интегральных МОП-конденсаторов не требует дополнительных технологических приемов, так как операция получения слоя диэлектрика легко совмещается с одной из операций локальной диффузии. Верхним электродом конденсатора служит металлическая (обычно алюминиевая) пленка, а нижним - сильно легированная область полупроводника (ее удельное сопротивление 10-3 — 10-4 Ом*см), имеющая омический контакт с выводом. Обычно МОП-конденсаторы изолируют от остальных элементов ИМС обратно включенными р-п-переходами.
Толщина слоя диэлектрика МОП-конденсаторов должна быть не менее 0,1 мкм, а металлических пленок электродов — от 0,5 до 2 мкм. Удельная емкость МОП-конденсаторов обычно составляет: 400 — 650 пФ/мм2 при толщине диэлектрика 0,08 - 0,1 мкм, пробивное напряжение 80 В, добротность 10 -100 на частоте 10 МГц, допуск на номинальную емкость ± 20%.
Преимуществами МОП-конденсаторов по сравнению с диффузионными являются их неполярность и нулевой коэффициент напряжения. Следовательно, к ним может быть приложено напряжение любой полярности, а номинальная емкость не зависит от приложенного напряжения. Кроме того, поскольку удельное сопротивление кремниевых пластин невелико, добротность таких конденсаторов может достигать 1000 и более. Как в диффузионных, так и в МОП-конденсаторах возникает паразитная емкость, обусловленная влиянием заземленной подложки, играющей роль дополнительного электрода.
ДИОДЫ ИМС
Диоды ИМС чаще всего используют в качестве выпрямителей, т. е. элементов, обладающих однонаправленной проводимостью.
При создании диодных структур для полупроводниковых ИМС необходимо учитывать параметры, определяющие вольт-амперную характеристику, быстродействие, емкости р-п-перехода между ним и пластиной, а также ток утечки. В качестве диодов обычно используются эмиттерные и коллекторные переходы биполярных транзисторов.
В полупроводниковых ИМС применяют различные схемы включения транзисторов в качестве диодов, т. е. диоды ИМС представляют собой определенным образом включенные биполярные транзисторы. Для диодного включения биполярного транзистора после формирования всех элементов ИМС наносят соответствующую внутрисхемную металлизацию.
Пять вариантов (I - V) построения диодов ИМС на основе планарно-эпитаксиального транзистора показаны на рис. 65. В варианте I использован переход эмиттер - база транзистора при короткозамкнутом переходе база — коллектор; в варианте II — переход эмиттер — база при разомкнутой коллекторной цепи; в варианте III - переход база - коллектор

при отсутствии эмиттерной области (при формировании диода операция получения эмиттера исключается); в варианте IV коллектор и эмиттер короткозамкнуты, следовательно, образованы два параллельно включенных диода, один из которых представляет собой переход эмиттер — база, а другой — переход база — коллектор; в варианте V использован переход база — коллектор при короткозамкнутом переходе эмиттер - база.
Рис. 65. Варианты построения интегральных диодов на основе структуры планарно-эпитаксиального транзистора
Характерное отличие диодов ИМС от дискретных — наличие паразитных емкостей, создаваемых изолирующими р-п-переходами, и паразитного транзистора, областями которого являются база и коллектор структуры интегрального транзистора, на которой выполняются диод и подложка. Так как паразитный транзистор работает в режиме усиления, часть тока, проходящего через диод, ответвляется в пластину, т. е. ток на его входе не равен току на выходе. Значение ответвляющегося тока зависит от коэффициента передачи тока паразитного транзистора, включенного по схеме ОЭ. Вследствие того, что коэф фициент инжекции эмиттера паразитного транзистора обычно достаточно мал, коэффициент передачи тока такого транзистора в схеме ОЭ не превышает 1-3. Если ток, проходящий через диод, достаточно мал, влиянием паразитного транзистора можно пренебречь.
При обратном включении диода ИМС необходимо учитывать, что напряжения, прикладываемые к нему и к изолирующему р-п-переходу, не должны превышать пробивных напряжений. Максимально допустимое обратное напряжение для I, II и IV вариантов построения диодов ограничивается напряжением пробоя перехода эмиттер - база (обычно не превышает 10 В), для III и V вариантов - напряжением пробоя перехода коллектор — баз (50 — 60 В), а перехода коллектор — подложка обычно составляет более 70 В. Параметром, определяющим обратную ветвь вольт-амперной характеристики диода, является постоянный обратный то к, проходящий через него при включении в обратном направлении. Основная составляющая обратного тока кремниевых р-и-переходов - это ток термогенерации, зависящий от площади р-п-перехода и концентрации центров рекомбинации в области его объемного заряда. При всех вариантах включения диодов обратные токи изменяются в пределах 0,1 - 100 нА.
Кроме обычных выпрямительных диодов в полупроводниковых ИМС находят применение и другие типы, например стабилитроны (опорные диоды), которые реализуются по тем же принципам, конкретные схемы включения биполярных транзисторов выбираются в зависимости от заданного напряжения и температурной стабильности.
Для стабилизации напряжения до 10 В используют эмиттер-ный р-л-переход транзистора (вариантII), работающий в режиме электрического пробоя, а для стабилизации напряжения в несколько десятков вольт — включение транзистора с оборванной базой в режиме лавинного пробоя коллекторного р-п-перехода.
БИПОЛЯРНЫЕ ТРАНЗИСТОРЫ ИМС
Биполярные транзисторы являются основными элементами полупроводниковых ИМС. Поэтому исходя иэ предъявляемых требований структура активных областей транзисторов должна обеспечивать их оптимальные электрические характеристики.
Основными электрофизическими параметрами активных областей биполярных транзисторов являются: концентрации атомов легирующих примесей; подвижность электронов и дырок; времена жизни и скорости рекомбинации неосновных носителей; диэлектрическая проницаемость исходного полупроводникового материала. В большинстве случаев в ИМС используются транзисторы п-р-п-типа, преимущества которых по сравнению с транзисторами р-п-р-типа состоят в относительно высоком коэффициенте усиления, более высоком быстродействии и меньших токах утечки.
Наиболее часто биполярные транзисторы ИМС изолируют обратно включенным р-п-переходом и реже - диэлектриком (поликристаллическим кремнием, диоксидом или нитридом кремния, ситаллом, оксидом алюминия).
Структуры биполярных транзисторов ИМС, изолированных обратно включенным р-п-переходом и диэлектриком, показаны на рис. 66,а, б.
Транзисторы, изолированные р-п-переходом, как правило, имеют планарно-эпитаксиальную структуру со скрытым п+- слоем коллектора, т. е. изготовляются на исходной полупроводниковой пластине р-типа, на поверхность которой предварительно наращивают эпитаксиальный слой противоположного типа электропроводности, имеющий толщину 5 — 10 мкм. При формировании планарно-эпитаксиальных структур сначала локальной диффузией атомов бора р-типа в эпитаксиальном слое п-типа получают изолированные области п-типа.
Затем двумя последовательными локальными диффузиями соответственно атомов бора и фосфора в созданных локальных изолированных областях п-типа формируют р-п-переходы коллектор — база и эмиттер — база.
Распределение концентраций примесных атомов в активных областях планарно-эпитаксиального биполярного транзистора ИМС показано на рис. 67. Внутри изолированного кармана такого транзистора обычно создают так называемый скрытый п+-слой коллектора, имеющий высокую концентрацию атомов какого-либо элемента V группы. Для этого перед эпитаксиальным наращиванием слоя и-типа проводят дополнительную диффузию чаще всего сурьмы, имеющей относительно невысокий коэффициент диффузии. Скрытый слой увеличивает коэффициент усиления транзистора по току при его работе в инверсном режиме, что весьма существенно для обеспечения оптимального режима работы цифровых ИМС. Примесные атомы, введением которых получают базовую и эмиттерную области, распределяются неравномерно и имеют наибольшую концентрацию на поверхности пластины.
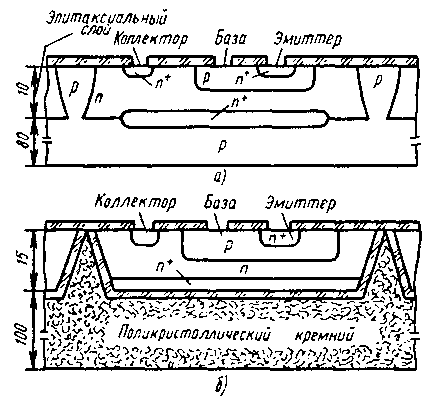
Рис. 66. Структуры интегрального биполярного транзистора, изолированные обратно смещенным р-п-переходом (а) и диэлектриком (б)

Рис. 67. Распределение концентраций примесных атомов в активных областях планарно-эпитаксиального биполярного транзистора ИМС:
1 - в коллекторной области, 2 - в скрытом п+-слое, 3, 4 — в базовой и эмиттерной областях
Транзисторы с диэлектрической изоляцией изготовляют, проводя локальную диффузию в предварительно сформированные карманы, изолированные друг от друга диэлектрическими слоями и располагающиеся внутри пластины из поликристаллического кремния. Распределение атомов легирующих примесей в активных областях таких транзисторов такое же, как в соответствующих областях пла-нарно-эпитаксиальных транзисторов с изолирующим р-п-переходом. Транзисторы с диэлектрической изоляцией имеют очень малые токи утечки и обладают высокой стабильностью параметров. Недостатки этих транзисторов - сложность технологического процесса получения изолированных карманов и высокая стоимость, что существенно ограничивают их применение в полупроводниковых ИМС.
Рассмотрим характерные особенности наиболее распространенной структуры интегрального транзистора со скрытым п+-слоем (рис. 68, а, б). Параметры слоев такой структуры выбирают, учитывая предъявляемые к каждому из них противоречивые требования.
Удельное объемное сопротивление кремниевой пластины должно быть от 1 до 10 ОмСм, что обеспечивает получение высокого пробивного напряжения перехода коллектор -пластина и его малой барьерной емкости, а толщина - достаточно большой (0,25 - 0,40 мм). Уровень легирования эпитаксиального п-слоя выбирают, исходя из двух противоречивых требований: высокое пробивное напряжение и малую емкость перехода коллектор - база обеспечивает низкий уровень легирования, а малое последовательное сопротивление коллекторной области - высокий. В большинстве случаев удельное сопротивление эпитаксиального слоя составляет 0,1 - 0,5 Ом*см, а его толщина изменяется от 2,5 до 10 мкм. Тонкие эпитаксиальные слои (до 3-5 мкм) существенно уменьшают паразитные емкости, что способствует повышению максимальной рабочей частоты ИМС.
В область коллектора, где формируется омический контакт для создания п+-области, проводят диффузию донорной примеси. Этим предупреждают инверсию слаболегированного эпитаксиального слоя, так как алюминий, используемый при выполнении омического контакта, является акцептором. В транзисторной структуре со скрытым высоколегированным слоем сопротивление коллекторной области обычно равно 10 -50 Ом*см.
Уровни легирования эмиттерной и базовой областей также выбирают с учетом нескольких противоречивых требований. В частности, для увеличения коэффициента инжекции эмиттера и повышения пробивного напряжения перехода эмиттер - база уровень легирования базовой области должен быть довольно низким. Однако сильное его снижение привило бы к недопустимому возрастанию паразитного омического сопротивления между контактом базы и ее активной областью.

Рис. 68. Структура интегрального транзистора со скрытым п+-слоем
Кроме того, если поверхностная концентрация базового слоя становится меньше 5 -1016 см -3, на его поверхности может образоваться инверсная л-область, наводимая нескомпенсированным положительным зарядом, локализованным в защитном слое диоксида кремния. В результате между коллекторной и эмиттерной областями возникает проводящий закорачивающий слой.
Высокий уровень легирования эмиттера необходим для получения большого коэффициента инжекции. Но при очень высоких уровнях легирования кремния (до1021см -3), близких к пределу растворимости, искажается структура кристаллической решетки, что уменьшает время жизни неосновных носителей заряда в базе и, следовательно, коэффициент инжекции.
Как видно из рис. 68, а, структура планарно-эпитаксиального транзистора полупроводниковой ИМС отличается от структуры дискретного транзистора тем, что его коллекторный вывод выполнен на верхней стороне исходной подложки, что обусловливает более высокое последовательное сопротивление коллекторной области. Скрытый п+-слой шунтирует высокое сопротивление коллекторной области и уменьшает коэффициент усиления паразитного транзистора р-п-р-типа, образующегося между базой р-типа и подложкой р-типа при прямом включении перехода база - коллектор.
Внутри базовой области транзистора, изготовленного локальными диффузионными процессами, возникает сильное электрическое поле, обусловленное изменением примесной концентрации. Поэтому перенос неосновных носителей заряда через базу осуществляется как в результате их диффузии, так и дрейфа под действием электрического поля. Поскольку тол-шина активной области базы очень мала, время пролета неосновных носителей заряда через базу не является основным фактором, определяющим частотные свойства интегральных транзисторов. В большинстве случаев частотные характеристики транзисторов ИМС зависят от паразитных емкостей р-п-переходов и последовательных сопротивлений коллекторной и базовой областей транзисторов. Влияние паразитных емкостей и сопротивлений может быть снижено максимально возможным уменьшением геометрических размеров транзисторов.
КЛАССИФИКАЦИЯ ИМС