Технология получения монокристаллического Si
Московский Государственный Технический Университет им. Баумана
Физико-химические основы технологии электронных средств
Реферат на тему:
Технология получения монокристаллического Si
Преподаватель: Григорьев Виктор Петрович
Студент: Малов М.С.
Группа: РТ2-41
Москва 2004
План:
Полупроводниковая технология
|
3
|
Кремний
|
|
- кристаллическая решетка кремния
|
4
|
- дефекты реальных кристаллов кремния
|
4
|
Этапы производства кремния
|
9
|
Получение технического кремния
|
10
|
Получения трихлорсилана (ТХС)
|
11
|
Очистка ТХС
|
13
|
Другие методы получения газовых соединений Si
|
15
|
Восстановление очищенного трихлорсилана
|
16
|
Получение поликристаллических кремния из моносилана SiH4
|
18
|
Производство монокристаллов кремния
|
20
|
|
|
20
|
- Бестигельной зонной плавки (БЗП)
|
26
|
Литература
|
30
|
Полупроводниковая технология начала свое становление с 1946 года, когда Бардин и Шокли изобрели биполярный транзистор. На первом этапе развития микроэлектронного производства в качестве исходного материала использовался германий. В настоящее время 98 % от общего числа интегральных схем изготавливаются на основе кремния.
Кремниевые полупроводниковые приборы по сравнению с германиевыми имеют ряд преимуществ:
- Si p-n переходы обладают низкими токами утечки, что определяет более высокие пробивные напряжения кремниевых выпрямителей;
- у кремния более высокая, чем у Ge область рабочих температур (до 150 и 70 градусов Цельсия соответственно);
- кремний является технологически удобным материалом: его легко обрабатывать, на нем легко получать диэлектрические пленки SiO2, которые затем успешно используются в технологических циклах;
- кремниевая технология является менее затратной. Получение химически чистого Si в 10 раз дешевле, чем Ge.
Вышеперечисленные преимущества кремниевой технологии имеют место в связи со следующими его особенностями:
- большое содержание кремния в виде минералов в земной коре (25 % от ее массы);
- простота его добычи (содержится в обычном речном песке) и переработки;
- существование "родного" не растворимого в воде окисного слоя SiO2 хорошего качества;
- большая, чем у германия ширина запрещенной зоны (Eg = 1.12 эВ и Eg = 0.66 эВ соответственно).
Кремний
Кремний обладает алмазоподобной кристаллической решеткой, которая может быть представлена в виде двух взаимопроникающих гранецентрированных решеток. Параметр решетки - 0.54 нм, кратчайшее расстояние между атомами - 0.23 нм. Легирующие атомы замещают атомы кремния, занимая их место в кристаллической решетке. Основными легирующими атомами являются фосфор (5ти валентный донор замещения) и бор (3-х валентный акцептор замещения). Их концентрация обычно не превышает 10-8 атомных процента.

Реальные кристаллы отличаются от идеальных следующим:
- они не бесконечны и поверхностные атомы обладают свободными связями
- атомы в решетке смещены относительно идеального положения в следствие термических колебаний
- реальные кристаллы содержат дефекты
С точки зрения размерности выделяют следующие типы дефектов реальных кристаллов:
К точечным дефектам относятся:
- дефекты по Шоттки,
- дефекты по Френкелю,
- атомы примеси в положении замещения,
- атомы примеси в междоузлии.
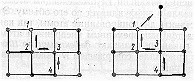
Дефект по Шоттки представляет собой вакансию в кристаллической решетке. Вакансия образуется, как правило, на поверхности кристалла. При этом атом или покидает решетку или остается с ней связанным. В дальнейшем вакансия мигрирует в объем кристалла за счет его тепловой энергии. В условиях термодинамического равновесия концентрация этих дефектов NШ задается уравнением
NШ= C*exp(-W/kT),
где C - константа, W - энергия образования данного вида дефекта.
Для кремния значение W= 2,6 эВ.

Дефект по Френкелю представляет собой вакансию и междоузельный атом. Концентрация этих дефектов вычисляется также по формуле, но с большим значением энергии образования междоузельного атома W= 4,5 эВ. Вакансия и междоузельный атомы перемещаются внутри решетки за счет тепловой энергии.

Возможно внедрение примесных атомов в кристаллическую решетку. При этом атомы примеси, находящиеся в положении замещения, создают энергетические уровни в запрещенной зоне полупроводника.
Атомы примеси, находящиеся в междоузлиях, не создают этих уровней, но влияют на механические свойства полупроводника.
К линейным дефектам относятся:


Краевые дислокации возникают за счет параллельного смещения атомов одной плоскости относительно другой на одинаковое расстояние b в направлении параллельном возможному перемещению дислокации. Винтовые дислокации также возникают за счет смещения атомных плоскостей, но атомы смещаются на разные расстояния в направлении перпендикулярном перемещению дислокации. Оба типа дефектов образуются за счет механических напряжений, существующих в кристалле, и обусловлены градиентом температуры или большой концентрации примесных атомов. Краевые дислокации в кристаллах, используемых для производства ИС, как правило, отсутствуют.
К поверхностным дефектам относятся:
- границы зерен монокристаллов,
- двойниковые границы.

Двойникование - изменение ориентации кристалла вдоль некоторой плоскости, называемой плоскостью двойникования BC (см. рис. 1). Эти дефекты возникают в процессе роста в определенных частях кристаллического слитка. Для производства ИС такие кристаллы не используют, их отбраковывают.
- Объемные дефекты в кремнии
Одним из проявлений трехмерных нарушений в кристаллической решетке являются микродефекты и преципитаты (фаза, в которой выделяются примесные атомы, в случае превышения уровня растворимости в веществе при данной температуре).
При росте кристаллов кремния с очень низкой плотностью дислокаций возникает тип дефектов, которые, вероятно, характерны исключительно для полупроводниковых кристаллов и в настоящее время интенсивно исследуются. Из-за малого размера их называют микродефектами. Картина распределения микродефектов в поперечном сечении кристалла обычно имеет вид спирали, поэтому ее называют swirl-картиной. Swirl по-английски означает "воронка, спираль". Swirl-картина обнаруживается и в кристаллах выращенных по методу Чохральского и в кристаллах зонной плавки независимо от их кристаллографической ориентации. Впервые такие дефекты наблюдались при избирательном травлении пластин бездислокационного кремния. В них обнаружены дефекты, отличающиеся от дислокаций, дефектов упаковки, двойников, преципитатов и межзеренных границ. Они давали фигуры травления, названные "некристалографическими" или "пустыми" ямками травления. Некристаллографические ямки не имеют определенной ориентации относительно кристалла или друг друга. Они имеют плоское дно и, следовательно, обусловлены вытравливанием локализованных, приблизительно сферических дефектов, отличных от дислокаций, которые являются линейными дефектами и дают при травлении "глубокие" ямки в местах своего выхода на поверхность.
В исследованных кристаллах с помощью рентгеновской топографии и избирательного травления были идентифицированы два типа микродефектов, отличающихся по размеру и концентрации. Микродефекты большого размера, названные А - дефектами, располагаются главным образом в областях, удаленных от поверхности кристалла и от краев пластин. Микродефекты меньшего размера (В - дефекты) наблюдаются во всем объеме кристалла вплоть до самой боковой его поверхности.
Этапы производства кремния
Технология получения монокристаллов полупроводникового кремния состоит из следующих этапов:
- получение технического кремния;
- превращение кремния в легколетучее соединение, котоВнрое после очистки может быть легко восстановлено;
- очистка и восВнстановление соединения, получение кремния в виде поликристаллиВнческих стержней;
- конечная очистка кремния методом кристаллизаВнции;
- выращивание легированных монокристаллов

Основные этапы производства кремния
Получение технического кремния
Исходным сырьем для большинства изделий микроэлектронной промышленности служит электронный кремний. Первым этапом его получения является изготовление сырья, называемого техническим (металлургическим) кремнием.

Этот технологический этап реализуется с помощью дуговой печи с погруженным в нее электродом. Печь загружается кварцитом SiO2 и углеродом в виде угля, щепок и кокса. Температура реакции Т = 1800 0С, энергоемкость W = 13 кВт/час. В печи происходит ряд промежуточных реакций. Результирующая реакция может быть представлена в виде:
SiC(тв) + SiO2(тв) тЖТ Si(тв) + SiO2(газ) + CO(газ) (1)
Получаемый таким образом технический кремний содержит 98 тАФ99 % Si, 1 тАФ2 % Fe, Аu, В, Р, Са, Cr, Cu, Mg, Mn, Ni, Ti, V, Zn и др.
Получения трихлорсилана (ТХС)
Современная технология поликристаллического кремния основана на процессе водородного восстановления трихлорсилана, восстановления тетрахлорида кремния цинком и пиролиза моносилана, Большую часть кремния (около 80 %) получают путем водородного восстановления трихлорсилана (ТХС). Достоинства этого процесса тАФ легкость и экономичность получения ТХС, эффективность очистки ТХС, выВнсокое извлечение и большая скорость осаждения кремния (извлеВнчение кремния при использовании тетрахлорида кремния составВнляет 15 %, а при использовании ТХС тАФ не менее 30 %), меньшая себестоимость продукции.
Трихлорсилан обычно получают путем гидрохлорирования кремВнния: взаимодействием технического кремния с хлористым водороВндом или со смесью газов, содержащих хлористый водород, при темВнпературе 260тАФ400 В°С.
Процесс синтеза трихлорсилана сопровождается побочными реакциями образования тетрахлорида кремния и других хлорсила-нов, а также галогенидов металлов, например АlСl3, ВСl3, FeCl3 и т.д. Реакции получения хлорсиланов кремния являются обратиВнмыми и экзотермическими:
Si(T) + ЗНСl(Г) тЖТ SiHCl3(Г) + H2(Г) (2)
Si(T) + 4НСl(Г) тЖТ SiCl4(Г) + 2Н2(Г) (3)
При температуре выше 300 В°С ТХС в продуктах реакций почти полностью отсутствует. Для повышения выхода ТХС температуру процесса снижают, что приводит к значительному замедлению скоВнрости реакции (3). Для увеличения скорости реакции (2) исВнпользуют катализаторы (медь, железо, алюминий и др.). Так, наВнпример, при введении в исходный кремний до 5 % меди содержание ТХС в смеси продуктов реакции при температуре 265 В°С доходит до 95 %.
Синтез ТХС ведут в реакторе ВлкипящегоВ» слоя, в который сверху непрерывно подают порошок технического кремния с размером часВнтиц 0,01 тАФ 1 мм. Псевдоожиженный слой частиц толщиной 200 тАФ 600 мм создают встречным потоком хлористого водорода, который поступает в нижнюю часть реактора со скоростью 1 тАФ8 см/с. Этим самым обеспечивается перевод гетерогенного химико-технологического процесса из диффузионной в кинетическую область. Так как процесс является экзотермическим, то для стабилизации режима в заданном интервале температур осуществляют интенсивный отвод теплоты и тщательный контроль температуры на разных уровнях псевдоожиженного слоя. Кроме температуры контролируют расход хлористого водорода и давление в реакторе.
Значительное влияние на выход ТХС оказывает присутствие примесей воды и кислорода в исходных компонентах. Эти примеси, окисляя порошок кремния, приводят к образованию на его поверхВнности плотных слоев SiO2, препятствующих взаимодействию кремВнния с хлористым водородом и соответственно снижающих выход ТХС. Так, например, при увеличении содержания Н2О в НСl с 0,3 до 0,4 % выход ТХС уменьшается с 90 до 65 %. В связи с этим хлористый водород, а также порошок кремния перед синтезом ТХС проходят тщательную осушку и очистку от кислорода.
Образующаяся в процессе синтеза ТХС парогазовая смесь постуВнпает в зону охлаждения, где ее быстро охлаждают до 40 тАФ130 В°С, в результате чего выделяются в виде пыли твердые частицы примеси (хлориды железа, алюминия и др.), которые вместе с частицами непрореагировавшего кремния и полихлоридов (SinCl2n+2) затем отделяются с помощью фильтров. После очистки от пыли (являюВнщейся взрывоопасным продуктом) парогазовая смесь поступает на конденсацию при температуре тАФ70 В°С. Происходит отделение SiHCl3 и SiCl4 (температуры кипения 31,8 и 57,2 В°С соответственно) от водорода и НСl (температура кипения 84 В°С). Полученная в реВнзультате конденсации смесь состоит в основном из ТХС (до 90тАФ 95 %), остальное тАФ тетрахлорид кремния, который отделяют затем ректификацией. Выделяемый в результате разделения тетрахлорид кремния в дальнейшем используют для производства силиконов, кварцевого стекла, а также для получения трихлорсилана путем дополнительного гидрирования в присутствии катализатора.
Очистка ТХС
Получаемый ТХС содержит большое количество примесей, очистВнка от которых представляет сложную задачу. Наиболее эффективВнным методом очистки является ректификация, однако осуществить полную и глубокую очистку от примесей, имеющих различную фиВнзико-химическую природу, применяя только ректификацию, сложВнно. В связи с этим для увеличения глубины очистки по ряду примеВнсей применяются дополнительные меры.
Так, например, для примесей, трудно очищаемых кристаллизаВнционными методами (бор, фосфор, углерод), необходима наиболее глубокая очистка ТХС. Поэтому для повышения эффективности очистки эти микропримеси переводят в нелетучие или комплексные соединения. Для очистки от бора, например, пары ТХС пропускают через алюминиевую стружку при 120 В°С. Поверхность стружки, поглощая бор, приводит к почти полной очистке от него ТХС. ПоВнбочно образующийся хлорид алюминия далее возгоняют при темпеВнратере 220тАФ250 В°С, а затем отделяют фракционной конденсацией.
Кроме алюминия могут быть использованы серебро, медь или сурьВнма. Добавка меди к алюминию позволяет одновременно очищать ТХС от мышьяка и сурьмы. Повысить эффективность очистки от бора позволяет также введение в ТХС пента- или оксихлоридев фосВнфора. При этом образуются нелетучие комплексные соединения фосВнфора с бором состава РСl5В·ВСl3 или РОС13В·ВСl3, которые затем отдеВнляют ректификацией. Перевод бора в нелетучие соединения может быть также осуществлен путем добавления в ТХС трифенилхлорВнметана (или триметиламина, ацетонитрила, аминокислоты, кетона и т. д.), приводящего к образованию с бором комплекса типа (С6Н5)3С В·ВСl3, который затем удаляют ректификацией. Очистку от борсодержащих примесей осуществляют также адсорбцией в реакВнторах, заполненных алюмогелем или другими гелями (TiO2, Fe2O3, Mg(OH)2) с последующей ректификацией ТХС.
Для очистки от фосфора ТХС насыщают хлором с переводом трихлорида фосфора в пентахлорид. При добавлении в раствор хлоВнрида алюминия образуется нелетучее соединение РСl5 В·АlСl3, котоВнрое затем удаляется ректификацией.
Контроль чистоты получаемого после очистки ТХС осуществляВнют методами ИК-спектроскопии, хроматографии, а также измереВннием типа и величины проводимости тестовых образцов кремния, получаемых из проб ТХС. Тестовый метод существует в двух модифиВнкациях. В соответствии с первой на лабораторной установке осажВндением из газовой фазы получают поликристаллический стержень кремния диаметром 10тАФ20 мм. Далее из него бестигельной зонной плавкой выращивают контрольный монокристалл, по типу провоВндимости и удельному сопротивлению которого судят о чистоте ТХС. Для определения концентрации доноров проводят один проход зоны в аргоне или вакууме и получают монокристалл n-типа, по удельному сопротивлению которого судят о чистоте по донорам (удельное сопротивление по донорам); для определения концентраВнции бора приводят 5тАФ15 проходов зоны в вакууме, в результате чего получают монокристалл р-типа, по удельному сопротивлению которого судят о чистоте по бору (удельное сопротивление по бору).
По второй модификации тестового метода монокристалл кремВнния выращивают непосредственно из газовой фазы на монокристалВнлический стержень в миниатюрном кварцевом реакторе и далее измеряют его удельное сопротивление.
Остаточное содержание микропримесей в ТХС после очистки не должно превышать, % мас: бора тАФ 3В·10-8, фосфоратАФ 1В·10-7, мышьяка тАФ 5В·10-10, углерода (в виде углеводородов) тАФ 5В·10-7.
По электрическим измерениям тестовых образцов остаточное содержание доноров должно обеспечивать удельное сопротивление кремния n-типа не менее 5000 ОмВ·см, а по акцепторам у кристаллов р-типа тАФ не менее 8000 ОмВ·см.
Другие методы получения газовых соединений Si
Технически и экономически конкурентоспособным по сравнению с рассмотренным является также метод получения поликристаллического кремния путем разложения силана SiH4 высокой чистоты. процесс получения которого сводится к следующему.
Путем сплавления технического кремния и магния в водороде при 550В°С получают силицид магния Mg2Si, который затем разлагают хлоридом аммония по реакции
Mg2Si+4NH4ClтЖТSiH4+2MgCl2+ +4NH3 (4)
в среде жидкого аммиака при температуре тАФ30 В°С. ОтдеВнляемый моносилан далее поступает на ректификационную очистку, в результате которой содержание примесей снижается до уровня менее 10-8 тАФ 10-7%.
Известны и другие методы получения летучих соединений кремВнния тАФ хлорирование или иодирование технического кремния, проВндуктами которых являются тетрахлорид SiCl4 или тетраиодид кремВнния SiJ4.
Восстановление очищенного трихлорсилана
Восстановление очищенного трихлорсилана и в результате этого получение поликристаллического кремния проводят в атмосфере водорода
SiHCl3(Г) + H2(Г) тЖТSi(T) + 3HCl(Г) (5)

на поверхности разогретых кремниевых стержней тАФ основах диаметром 4тАФ8 мм (иногда до 30 мм), получаемых методом выращиваВнния с пьедестала. В некоторых технологиях вместо цилиндрических стержней используются пластинчатые (толщиной 1тАФ5 мм и шириной 30тАФ100 мм) с большей площадью осаждения. Материалом для выращивания стержней служит высококачественный поликристаллический кремний. Поверхность стержней тАУ основ подвергают ультраВнзвуковой очистке, травлению в смеси кислот (например, HF+ + HNO3), отмывке и сушке. К стержням тАУ основам для получения выВнсококачественного поликристаллического кремния предъявляются высокие требования по чистоте: они должны иметь удельное сопроВнтивление по донорам >700 ОмВ·см и по бору >5000 ОмВ·см.
Из стержней изготовляют электронагреватели (например, П-обВнразной формы) и их нагрев осуществляют пропусканием электриВнческого тока. По мере роста диаметра стержней силу тока постеВнпенно увеличивают.
Выбор условий водородного восстановления ТХС осуществляют на основе оптимальной взаимосвязи следующих параметров проВнцесса:
- равновесной степени превращения SiHCl3 в Si, кристаллиВнческой структуры получаемых стержней,
- температуры процесса,
- энергозатрат,
- мольного отношения Н2: SiHCl3,
- скорости осаждения кремния.
Оптимальными условиями процесса восстановления считают температуру 1100тАФ1150 В°С, мольное отношение Н2 : SiHCl3 в преВнделах 5 тАФ15, плотность подачи ТХС 0,004 моль/(ч В·см2). При темВнпературе стержней ниже оптимальной повышается степень превраВнщения ТХС в тетрахлорид кремния и уменьшается выход кремния. Увеличение температуры приводит к существенному возрастанию энергозатрат. При оптимальном мольном отношении Н2 : SiHCl3 = 5 тАФ15 стержни имеют плотную мелкокристаллическую структуру и относительно ровную поверхность. За пределами этих отношений образуется неровная поверхность, структура стержней становится крупнокристаллической с включениями газовых пор, которые при последующем плавлении поликремния в процессе выращивания кристаллов приводят к бурлению и разбрызгиванию расплава.
Количество стержней, устанавливаемых в различных промышВнленных реакторах, колеблется от 2 до 16, длина каждого стержня составляет до 2 м, конечный диаметр 150тАФ250 мм. За счет взаимного нагрева стержней скорость осаждения кремния в многостержневых аппаратах выше, чем в двухстержневых; скорость роста диаметра стержней достигает 0,5 мм/ч, энергозатраты составляют 3000 кВт В·ч/кг.
Для повышения чистоты получаемого кремния производят тщаВнтельную очистку водорода, реакторы делают из специальных стаВнлей, а также защищают их поверхность от взаимодействия с газовой средой путем введения дополнительных кварцевых (кремниевых) колпаков, отделяющих реакционный объем от стенок реактора. Хорошей защитой стенок реактора является покрытие их защитныВнми пленками, например полихлорсиланом.
Получение поликристаллических кремния из моносилана SiH4
Получение поликристаллических стержней кремния путем термического разложения моносилана SiH4 производится по аналогичВнной методике при температурах 1000 В°С. Образующийся при разВнложении водород SiH4(Г)->Si(T) + 2Н2(Г) обладает высокой стеВнпенью чистоты и используется в сопутствующем производстве. ПоВнлучаемый по этой технологии поликремний обладает более высокой степенью чистоты, чем кремний, получаемый восстановлением ТХС.
Извлечение кремния из SiCl4 и SiJ4 осуществляют восстановлеВннием тетрахлорида кремния цинком либо термической диссоциацией тетраиодида.
Получаемые поликристаллические стержни перед использоваВннием в процессах выращивания монокристаллов методом ЧохральВнского разламывают на удобные для загрузки в тигель куски или разрезают на мерные заготовки. Для процесса бестигельной зонВнной плавки стержни обрабатывают под нужный диаметр шлифовкой. Удаление поверхностных слоев, обогащенных примесями и газами, кроме того, предотвращает разбрызгивание кремния из расплавленВнной зоны.
Современные технологические схемы получения поликристаллиВнческого кремния включают в себя регенерацию и повторное исВнпользование всех компонентов и продуктов реакций восстановления (пиролиза), что улучшает технико-экономические показатели проВнцесса, снижает себестоимость получаемого кремния, делает процесс экологически более чистым.
Рассмотренный процесс осаждения поликристаллического кремВнния используется также для получения на его основе поликристалВнлических труб на углеродных оправках. Вследствие высокой чистоты и прочности эти трубы применяются вместо кварцевых в печах высокотемпературных процессов (свыше 1200 В°С) в технологии полупроводниковых и микроэлектронных приборов. Кремниевые труВнбы не подвержены просаживанию или другой деформации в течение нескольких лет эксплуатации, несмотря на постоянное температурВнное циклирование между 900 и 1250 В°С, тогда как кварцевые трубы имеют ограниченный срок службы при тех же процессах.
Потребление поликристаллического кремния электронной промышленностью составляет несколько тысяч тонн в год.
Для получения кремния высокой чистоВнты поликристаллические стержни подвергают кристаллизационной очистке методом зонной плавки в вакууме. При этом помимо крисВнталлизационной очистки кремния от нелетучих примесей (преимуВнщественно акцепторов) происходит существенная очистка его от летучих доноров за счет испарения их из расплавленной зоны. Так, после 15 проходов расплавленной зоны со скоростью 3 мм/мин, поВнлучают монокристаллы кремния р-типа электропроводности с остаточной концентрацией примеси менее 1013 см-3 и удельным соВнпротивлением (по бору) более 104 Ом*см.
Производство монокристаллов кремния
Производство монокристаллов кремния в основном осуществляВнют методом Чохральского (до 80тАФ90 % потребляемого электронной промышленностью) и в меньшей степени методом бестигельной зонВнной плавки.
Метод Чохральского
Идея метода получения кристаллов по Чохральскому заключается в росте монокристалла за счет перехода атомов из жидкой или газообразной фазы вещества в твердую фазу на их границе раздела.

Применительно к кремнию этот процесс может быть охарактеризован как однокомпонентная ростовая система жидкость - твердое тело.
Скорость роста V определяется числом мест на поверхности растущего кристалла для присоединения атомов, поступающих из жидкой фазы, и особенностями переноса на границе раздела.
Оборудование для выращивания монокристаллического кремния
Установка состоит из следующих блоков
- печь, включающая в себя тигель (8), контейнер для поддержки тигля (14),Ва нагреватель (15), источник питания (12), камеру высокотемпературной зоны (6) и изоляцию (3, 16);
- механизм вытягивания кристалла, включающий в себя стержень с затравкой (5), механизм вращения затравки (1) и устройство ее зажима, устройство вращения и подъема тигля (11);
- устройство для управления составом атмосферы (4 - газовый вход, 9 - выхлоп, 10 - вакуумный насос);
- блок управления, состоящий из микропроцессора, датчиков температуры и диаметра растущего слитка (13, 19) и устройств ввода;
дополнительные устройства: смотровое окно - 17, кожух - 2.

Технология процесса.
Затравочный монокристалл высокого качества опускается в расплав кремния и одновременно вращается. Получение расплавленного поликремния происходит в тигле в инертной атмосфере (аргона при разрежении ~104 Па.) при температуре, незначительно превосходящей точку плавления кремния Т = 1415 В°С. Тигель вращается в направлении противоположном вращению монокристалла для осуществления перемешивания расплава и сведению к минимуму неоднородности распределения температуры. Выращивание при разрежении поВнзволяет частично очистить расплав кремния от летучих примесей за счет их испарения, а также снизить образование на внутренней облицовке печи налета порошка монооксида кремния, попадание которого в расплав приводит к образованию дефектов в кристалле и может нарушить монокристаллический рост.

В начале процесса роста монокристалла часть затравочного монокристаллаВа расплавляется для устранения в нем участков с повышенной плотностью механических напряжений и дефектами. Затем происходит постепенное вытягивание монокристалла из расплава.
Для получения монокристаллов кремния методом Чохральского разработано и широко используется высокопроизводительное автоматизированное оборудование, обеспечивающее воспроизводимое получение бездислокационных монокристаллов диаметром до 200тАФ 300 мм. С увеличением загрузки и диаметра кристаллов стоимость их получения уменьшается. Однако в расплавах большой массы {60тАФ120 кг) характер конвективных потоков усложняется, что созВндает дополнительные трудности для обеспечения требуемых свойств материала. Кроме того, при больших массах расплава снижение стоимости становится незначительным за счет высокой стоимости кварцевого тигля и уменьшения скорости выращивания кристаллов из-за трудностей отвода скрытой теплоты кристаллизации. В связи с этим с целью дальнейшего повышения производительности процесса и для уменьшения объема расплава, из которого производится выращивание кристаллов, интенсивное развитие получили установки полунепрерывного выращивания. В таких установках производится дополнительная непрерывная или периодическая загрузка кремния в тигель б,ез охлаждения печи, например путем подпитки расплава жидкой фазой из другого тигля, который, в свою очередь, также может периодически или непрерывно подпитываться твердой фазой. Такое усовершенствование метода Чохральского позволяет снизить стоимость выращиваемых кристаллов на десятки процентов. Кроме того, при этом можно проводить выращивание из расплавов небольВншого и постоянного объема. Это облегчает регулирование и оптиВнмизацию конвективных потоков в расплаве и устраняет сегрегаВнционные неоднородности кристалла, обусловленные изменением объема расплава в процессе его роста.
Легирование
Для получения монокристаллов п- или р-типа с требуемым удельным сопротивлением проводят соответствующее легирование исходного поликристаллического кремния или расплава. В загруВнжаемый поликремний вводят соответствующие элементы (Р, В, As, Sb и др.) или их сплавы с кремнием, что повышает точность леВнгирования.
Окончательная обработка кремния

Из установки извлекают кремниевый слиток диаметром 20 - 50 см и длиной до 3 метров. Для получения из него кремниевых пластин заданной ориентации и толщиной в несколько десятых миллиметра производят следующие технологические операции.
1. Механическая обработка слитка: - отделение затравочной и хвостовой части слитка; - обдирка боковой поверхности до нужной толщины; - шлифовка одного или нескольких базовых срезов (для облегчения дальнейшей ориентации в технологических установках и для определения кристаллографической ориентации); - резка алмазными пилами слитка на пластины: (100) - точно по плоскости (111) - с разориентацией на несколько градусов. 2. Травление. На абразивном материале SiC или Al2O3 удаляются повреждения высотой более 10 мкм. Затем в смеси плавиковой, азотной и уксусной кислот, приготовленной в пропорции 1:4:3, или раствора щелочей натрия производится травление поверхности Si. 3. Полирование - получение зеркально гладкой поверхности. Используют смесь полирующей суспензии (коллоидный раствор частиц SiO2 размером 10 нм) с водой.
В окончательном виде кремний представляет из себя пластину диаметром 15 - 40 см, толщиной 0.5 - 0.65 мм с одной зеркальной поверхностью. Вид пластин с различной ориентацией поверхности и типом проводимости приведен на рисунке 6.
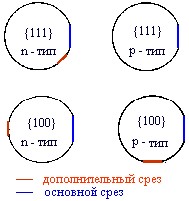
Основная часть монокристаллов кремния, получаемых методом Чохральского, используется для производства интегральных микВнросхем; незначительная часть (около 2 %) идет на изготовление солВннечных элементов. Метод является оптимальным для изготовления приборов, не требующих высоких значений удельного сопротивлеВнния (до 25 ОмВ·см) из-за загрязнения кислородом и другими примесяВнми из материала тигля.
Бестигельной зонной плавки (БЗП)
Выращивание кристаллов кремния методом бестигельной зонной плавки (БЗП) осуществляют на основе одновиткового индуктора (типа Влигольного ушкаВ»), внутренний диаметр которого меньше диаВнметра исходного поликристаллического стержня и кристалла. Во всех современных системах зонной плавки используется стационарВнное положение индуктора, а поликристаллический стержень и расВнтущий монокристалл перемещаются. Скорость выращивания крисВнталлов методом БЗП вдвое больше, чем по методу Чохральского, благодаря более высоким градиентам температуры. Из-за техничеВнских трудностей выращиваемые методом БЗП кристаллы кремния (их диаметр доведен до 150 мм) уступают по диаметру кристаллам, получаемым методом Чохральского. При бестигельной зонной плавВнке легирование выращиваемого кристалла, как правило, проводят из газовой фазы путем введения в газ-носитель (аргон) газообразных соединений легирующих примесей. При этом удельное сопротивлеВнние кристаллов может изменяться в широких пределах, достигая 200 ОмВ·см. При выращивании в вакууме получают монокристалВнлы с очень высоким сопротивлением тАФ до 3В·104 ОмВ·см. Для поВнлучения такого материала во избежание загрязнений не применяют резку или обдирку стержня поликристаллического кремния. ОстаВнточные доноры, кислород, углерод и тяжелые металлы удаляют из кремниевого стержня пятикратной зонной очисткой в вакууме. К неВндостаткам метода БЗП относится значительная радиальная неоднородность распределения удельного сопротивления (20тАФ30 %) полуВнчаемых кристаллов, которую можно уменьшить использованием трансмутационного легирования.
Монокристаллы кремния, получаемые методом БЗП, составляют около 10 % общего объема производимого монокристаллического кремния и идут в основном на изготовление дискретных приборов, особенно тиристоров большой мощности.
Дефекты монокристаллического Si
Кристаллы кремния, получаемые методами Чохральского и БЗП для целей твердотельной электроники, в подавляющем большинстВнве являются бездислокационными. Основными видами структурных дефектов в них являются микродефекты (МД) размером от долей нанометров до нескольких микрометров с концентрацией 107 см-3 и более. Различают в основном три вида МД: дислокационные петли, стабилизированные примесью, и их скопления (А-дефекты); сфериВнческие, удлиненные или плоские примесные преципитаты и частиВнцы плотной кремниевой фазы (В-дефекты) и скопления вакансий (Д-дефекты). Предполагается, что МД могут образовываться непосВнредственно в процессе кристаллизации, при обработке кристалла (термической, радиационной, механической и др.), а также в проВнцессе работы полупроводникового прибора. Так, при росте кристалВнла МД могут возникать в результате захвата растущим кристалВнлом примесных комплексов и частиц, обогащенных примесью, каВнпель расплава, а также агломератов атомов кремния. На послеросВнтовых этапах формирование МД происходит в основном в резульВнтате распада твердого раствора примеси или собственных точечных дефектов в кремнии на гетерогенных центрах или первичных МД, образовавшихся в процессе роста кристалла.
Основными фоновыми примесями в монокристаллах кремния явВнляются кислород, углерод, азот, быстродиффундирующие примеси тяжелых металлов.
Кислород в кремнии в зависимости от концентрации, формы существования и распределения может оказывать как отриВнцательное, так и положительное влияние на структурные и электВнрические свойства кристаллов. Концентрация кислорода в кристалВнлах, выращенных по методу Чохральского из кварцевого тигля, определяется следующими источниками: растворением тигля и поступлением кислорода в расплав из атмосферы камеры выращивания. В зависимости от вязкости расплава, характера конвективных поВнтоков в расплаве, скорости роста кристаллов концентрация кислоВнрода в выращенных кристаллах изменяется от 5В·1017 до 2В·1018 см-3. Предел растворимости кислорода в кристаллическом кремнии соВнставляет 1,8В·1018. С понижением температуры растворимость кисВнлорода резко падает. Для контролирования и уменьшения конВнцентрации кислорода в кристаллах кремния, выращиваемых метоВндом Чохральского, вместо кварцевых используют тигли, изготовВнленные из нитрида кремния, тщательно очищают атмосферу печи (аргон) от кислородсодержащих примесей.
Концентрация кислорода в кристаллах, получаемых методом БЗП, обычно составляет 2В·1015 тАФ 2В·1016 см -3.
Углерод в кремнии является одной из наиболее вредВнных фоновых примесей, оказывающей наряду с кислородом значиВнтельное влияние на электрические и структурные характеристики материала. Содержание углерода в кристаллах, получаемых по методу Чохральского и БЗП, составляет 5В·1016 тАФ 5*1017 см -3. РастВнворимость углерода в расплаве кремния при температуре плавления равна (2-4) В·1018 см -3, в кристаллах тАФ 6В·1017 см -3. Эффективный коэффициент распределения углерода в кремнии тАФ 0,07.
Основными источниками углерода в выращиваемых кристаллах является монооксид и диоксид углерода, а также исходный полиВнкристаллический кремний. Оксиды углерода образуются в резульВнтате взаимодействия монооксида кремния с графитом горячих элеВнментов теплового узла и подставки для тигля в установке для выВнтягивания кристаллов, в результате взаимодействия кварцевого тигля с графитовой подставкой, окисления графитовых элементов кислородом. Для снижения концентрации кислорода в кристаллах уменьшают его содержание в основных источниках, уменьшают чисВнло графитовых и углеродсодержащих узлов камеры выращивания или нанесения на них защитных покрытий.
Остаточная концентрация азота в кристаллах кремния, полученных по методам Чохральского и БЗП, не превышает 1012 см -3. Предел его растворимости в твердом кремнии при температуре плавления составляет 4,5В·1015 см -3, равновесный коэффициент расплавления равен 0,05. Основными источниками азоВнта являются газовая атмосфера, выделения из графита, тигель из нитрида кремния. Являясь донором, азот, кроме того, приводит к повышению значений критических напряжений образования дисВнлокаций в кремнии.
Концентрация быстродиффундирующих примесей тяжелых меВнталлов (Fe, Сu, Аu, Сr, Zn и др.) в кристаллах кремния, выращиваеВнмых методом Чохральского и БЗП, не превышает 5-Ю13, а в особо чистых, получаемых многократной зонной плавкой,тАФ5 В·1011 см -3.
Параметр
|
Метод Чохральского
|
Метод зонной плавки
|
Максимальный диаметр пластины, мм
|
150 - 400
|
200
|
Удельное сопротивление p- тип, Ом В·см
|
0.005-50
|
0.1-3000
|
Удельное сопротивление n- тип, Ом В·см
|
0.005-50
|
0.1-800
|
Ориентация
|
[111], [110], [100]
|
[111], [100]
|
Время жизни неосновных носителей, мкс
|
10-50
|
100-3000
|
Содержание кислорода, атом/см2
|
10-100
|
<10
|
Содержание углерода, атом/см2
|
10
|
<10
|
Литература
- Технология полупроводниковых и диэлектрических материалов Ю.М. Таиров В.Ф.Цветков Москва ВлВысшая школаВ» 1990г
- Оборудование полупроводникового производства Блинов, Кожитов, тАЭМАШИНОСТРОЕНИЕтАЭ 1986г
- Методы определения основных параметров полупроводниковых материалов. Л.П.Павлов. Москва. ВлВысшая школаВ». 1975г
Вместе с этим смотрят:
Тиристоры и некоторые другие ключевые приборыТравление п.п. ИМСТранзисторыТрансформатор напряжения